ACS Materials Lett. | 基于超低操作电压Nb₂O₅ CBRAM的多值存储应用及铜导电丝观察
英文原题:Ultralow Operating Voltage Nb₂O₅-Based Multilevel Resistive Memory with Direct Observation of Cu Conductive Filament

通讯作者:吕建国,浙江大学;黄靖云,浙江大学;叶志镇;浙江大学
作者:Bojing Lu (陆波静),Jigang Du (杜纪纲),Jianguo Lu (吕建国),* Siqin Li (李思嵚),Ruqi Yang (杨汝淇), Pingwei Liu (刘平伟),Jingyun Huang (黄靖云),* Lingxiang Chen (陈凌翔), FeiZhuge (诸葛飞), Zhizhen Ye (叶志镇)
高性能计算和大数据时代的到来对数据的存储和处理提出了越来越高的要求。阻变存储器(ReRAM)因其在新型非易失性存储器和神经拟态计算应用方面的巨大潜力而引起了广泛关注。导电桥阻变存储器(CBRAM)是ReRAM的一种,其顶部电极由活性金属组成。在过去的十多年中,科学家进行了许多努力,ReRAM也获得了很大的发展。但是目前阻变存储器仍然面临一些挑战阻碍其更广泛的应用,具体如下:(1)文献报道的ReRAM一般需要几伏的操作电压来实现电阻转变,高电压会增加功耗,并影响器件的稳定性,此外,晶体管的驱动电压和电流随着CMOS的工艺制程的缩进而不断降低,使得低压操作ReRAM更具优势和必要;(2)多值存储单元(MLC)是实现高密度ReRAM芯片的有效方法,尽管许多研究人员致力于研究MLC,但其不稳定性和读取窗口不足等问题仍然存在;(3)因为导电丝出现位置的随机性以及导电丝极小的尺寸,对导电丝的观察是一个具有挑战的研究。
CBRAM器件的阻变性能取决于阻变层材料。已被研究用作阻变层的材料包括典型的硫属元素化合物和各种二元氧化物。其中,使用硫属元素化合物为阻变层的CBRAM显示出较低的操作电压,因为作为阻变层的硫化物或硒化物通常为非晶结构,存在阳离子快速传输通道,因此其对应器件的操作电压较低,但硫化物或硒化物的导电性较高,这些器件的关态电流更高,高低阻态的开关比更小。另一方面,基于氧化物的CBRAM显示出较低的关态电流,但它们通常需要较大的操作电压(>1V)。为了获得低操作电压和高开关比的CBRAM,浙江大学吕建国团队提出非晶Nb2O5(α-Nb2O5)并研究其作为阻变层的CBRAM的电阻转变行为。溅射获得的Nb2O5薄膜通常呈现非晶结构,只有在500甚至800°C以上才会结晶,这比其他应用于CBRAM的氧化物要高。本文中,α-Nb2O5 CBRAM采用全室温工艺制造,不涉及任何热处理操作,具有高开/关比和超低操作电压。此外,作者提出了一种使器件击穿的方法来研究ReRAM中的导电丝。对击穿点的TEM测试有力地证明了Cu的迁移和Cu导电丝的存在。而且击穿器件的TEM结果也为超低操作电压和MLC性能提供了解释。

图1. α-Nb2O5 CBRAM器件的制备与表征
图1为对薄膜与器件进行的表征。XPS分析了磁控溅射制备的Nb2O5薄膜的化学价态和元素组成比。XRD结果表明常温下制备的Nb2O5薄膜为非晶态,且在600℃的温度下退火后仍然保持非晶结构,具有很好的热力学稳定性。TEM以及SEM用于表征器件横截面以及表面形貌。
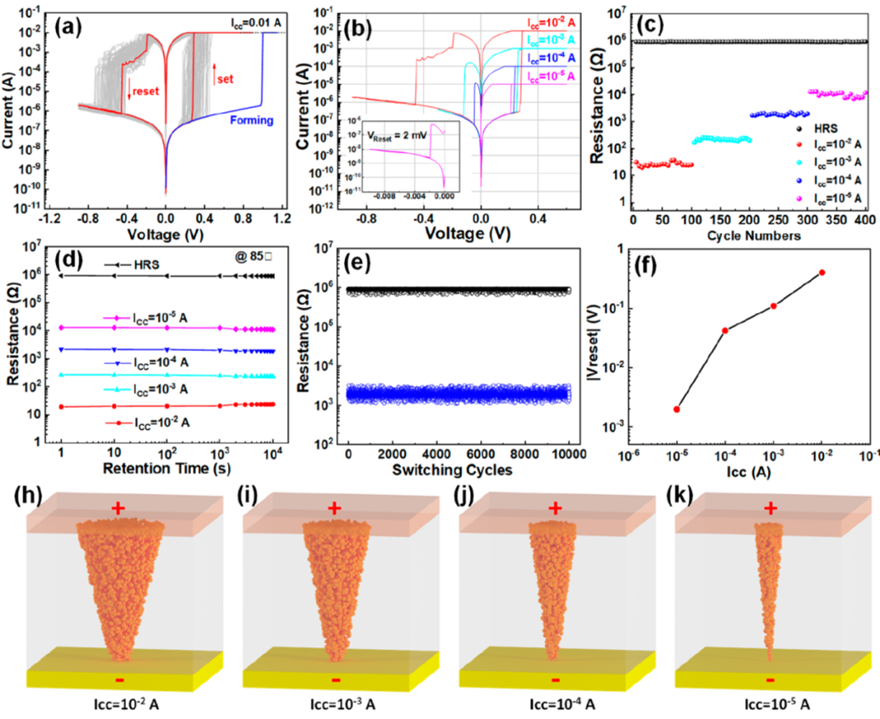
图2. α-Nb2O5 CBRAM器件的阻变性能
图2(a)显示了α-Nb2O5 CBRAM在扫描电压模式下的100个周期的阻变I-V曲线以及Forming过程的I-V曲线。Set(HRS到LRS)和Reset(LRS到HRS)操作可以由大约0.3 V的Vset和大约-0.5 V的Vreset触发,这比常见的ReRAM器件低得多。α-Nb2O5 CBRAM展示了高达~105的开关比,如此高的开关比可用于MLC应用。通过改变Icc来实现Nb2O5器件的MLC性能。α-Nb2O5 CBRAM器件在不同Icc下都能在相应的低阻态与高阻态之间多次转变,具有优异的稳定性。α-Nb2O5 CBRAM器件在不同的Icc下表现出不同的电阻状态。不同电阻态能够实现稳定的切变,每一级电阻值的统计分布很集中,变化很小,相邻的电阻状态很容易被区分,为器件提供了足够的读取窗口。通过改变Icc,除了实现了MLC性能之外,有趣的是,Reset电压随着与Icc的降低显著减小。特别是当Icc=0.00001 A时,Vreset仅为2 mV,要远小于其他低压操作阻变存储器文献报道的Reset电压。图2(h)-(k)所示的模型解释了如此小的Reset电压以及MLC特性。在不同的Icc下,α-Nb2O5阻变层中形成了不同大小粗细的Cu导电丝,越细小的导电丝只需要越小的reset电压就可以完成reset操作。特别是当Icc为10-5 A时,形成的Cu导电丝非常细,只需几毫伏就可以实现Reset操作。
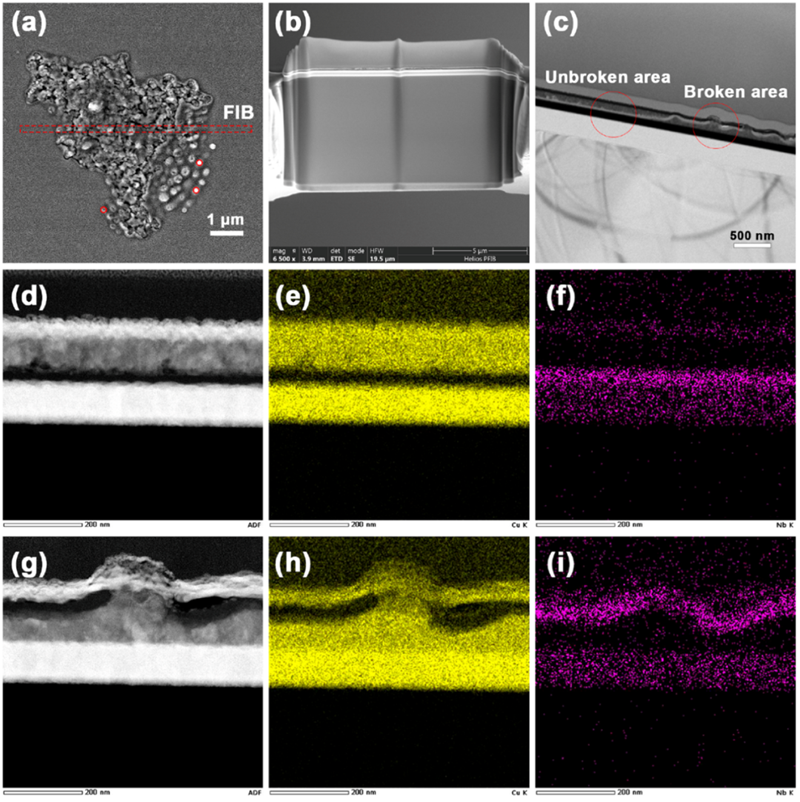
图3. Cu导电丝的探究
由于导电桥阻变存储器中金属导电丝的大小仅为纳米甚至亚纳米级别,而且导电丝位置具有随机性,很难通过TEM直接定位到导电丝。本文中,作者提出了一种创新性定位并观察导电丝的方法。当Icc设置为0.1 A(仪器最大Icc),偏压保持在1 V数秒后,α-Nb2O5 CBRAM器件就击穿失效了。图3.(a)为击穿点在扫描电镜下的图片。为了探究击穿点内部情况,使用FIB技术对器件进行切片取样。图3(b)为FIB切片后获取的样品图。图3(c)所示。横截面可被分成不同的区域,包括未损伤区域(Unbroken Area)和损伤区域(Broken Area)。未损伤区域为不受击穿影响的器件区域,该区域保持Au/Cu/Nb2O5/Au/Ti的堆叠结构,具有清晰分明的界面。击穿区域底部Au电极还保持完整,底电极以上的Nb2O5阻变层以及Cu电极层都有不同程度的损伤。在损伤区域,可以看到Cu元素贯穿了Nb2O5阻变层,形成了Cu导电丝。
总结
在这项工作中,作者提出了基于非晶Nb2O5的CBRAM,分别以Cu和Au作为顶部和底部电极。α-Nb2O5 CBRAM采用全室温工艺制备,具有稳健的稳定性、高开关比和超低操作电压。α-Nb2O5 CBRAM可以很好地用于多值存储,具有优异的性能,有望克服ReRAM在实际应用中面临的挑战。
1. α-Nb2O5 CBRAM器件表现出优异的电阻开关性能,开/关比高达105。复位电压随着限制电流的降低而显着降低。特别是当限制电流为10 μA时,Reset电压仅为2 mV。建立了模型并解释了如此小的操作电压的机制。
2. 如此高的比率可用于开发Nb2O5器件中的MLC性能。通过改变限制电流,在Nb2O5器件中展示了多级电阻开关特性。每一级电阻态都是统一的,相邻电阻态可被清楚地区分,提供了足够的读写窗口。
3. 为了研究导电丝,作者创新性地设计了击穿器件定位导电丝的方法。去除限制电流后,连续施加正偏压,使器件击穿。通过观察击穿点内部,证明了Cu的迁移和Cu导电丝的存在。
相关文章发表在期刊ACS Materials Letters上,浙江大学陆波静博士为文章第一作者,浙江大学吕建国副研究员,黄靖云教授,叶志镇院士为通讯作者。
扫描二维码阅读英文原文,或点此查看原文

ACS Materials Lett. 2023, 5, 5, 1350–1358
Publication Date: April 4, 2023
https://doi.org/10.1021/acsmaterialslett.2c01218
Copyright © 2023 American Chemical Society

如果篇首注明了授权来源,任何转载需获得来源方的许可!如果篇首未特别注明出处,本文版权属于 X-MOL ( x-mol.com ), 未经许可,谢绝转载!













































 京公网安备 11010802027423号
京公网安备 11010802027423号