当前位置:
X-MOL 学术
›
Adv. Funct. Mater.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Epitaxial Ferroelectric Hf0.5Zr0.5O2 Thin Films and Their Implementations in Memristors for Brain‐Inspired Computing
Advanced Functional Materials ( IF 18.5 ) Pub Date : 2018-10-16 , DOI: 10.1002/adfm.201806037 Herng Yau Yoong 1 , Haijun Wu 1 , Jianhui Zhao 2 , Han Wang 1 , Rui Guo 1 , Juanxiu Xiao 1 , Bangmin Zhang 1 , Ping Yang 3 , Stephen John Pennycook 1 , Ning Deng 4 , Xiaobing Yan 2 , Jingsheng Chen 1
Advanced Functional Materials ( IF 18.5 ) Pub Date : 2018-10-16 , DOI: 10.1002/adfm.201806037 Herng Yau Yoong 1 , Haijun Wu 1 , Jianhui Zhao 2 , Han Wang 1 , Rui Guo 1 , Juanxiu Xiao 1 , Bangmin Zhang 1 , Ping Yang 3 , Stephen John Pennycook 1 , Ning Deng 4 , Xiaobing Yan 2 , Jingsheng Chen 1
Affiliation
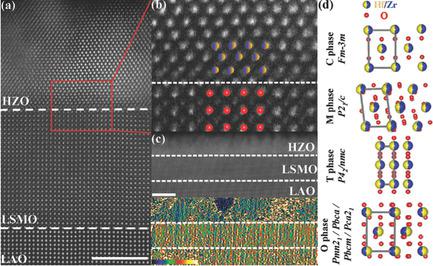
|
Doped‐HfO2 thin films with ferroelectricity have attracted great attention due to their potential application in semiconductor industry as negative capacitance and resistance switching memory. Despite Hf0.5Zr0.5O2 (HZO) thin films having the most robust ferroelectric properties among all doped‐HfO2 thin films, the realization of single orthorhombic phase HZO thin films is not achieved, while the direct evidence between the structural–properties relationship of orthorhombic phase HZO and ferroelectricity is not confirmed. In this work, the growth of single orthorhombic phase HZO thin films with decent ferroelectricity and resistive switching behavior is reported. With the aid of advanced structural characterization techniques, the HZO thin film is confirmed to be in the single orthorhombic phase. Next, using scanning probe microscopy techniques and macroscopic ferroelectric measurements, the single phase HZO thin films exhibit ferroelectric properties with a remanent polarization of about 20 µC cm−2. Interestingly, the HZO thin film shows ferroelectric resistive switching with an ROFF/RON ratio of about 16 100% with excellent device performance. Furthermore, brain‐like learning behavior is also observed in the HZO thin film. These results may serve to stimulate the study of ferroelectric properties of HZO thin films and their application in the electronic industry.
中文翻译:

外延铁电Hf0.5Zr0.5O2薄膜及其在脑启发计算忆阻器中的实现
具有铁电性的HfO 2掺杂薄膜由于在半导体工业中作为负电容和电阻切换存储器的潜在应用而备受关注。尽管Hf 0.5 Zr 0.5 O 2(HZO)薄膜在所有掺杂的HfO 2中具有最强的铁电性能薄膜,单斜方相HZO薄膜的实现尚未实现,而斜方相HZO的结构-性能关系与铁电之间的直接证据尚未得到证实。在这项工作中,报告了具有适当铁电性和电阻切换行为的单正交相HZO薄膜的生长。借助于先进的结构表征技术,可以确定HZO薄膜处于单斜方晶相。接下来,使用扫描探针显微镜技术和宏观铁电测量,单相HZO薄膜显示出铁电特性,剩余极化约为20 µC cm -2。有趣的是,HZO薄膜显示出具有R的铁电电阻切换OFF / R ON比率约为16 100%,具有出色的器件性能。此外,在HZO薄膜中也观察到了类似大脑的学习行为。这些结果可能有助于刺激HZO薄膜的铁电性能及其在电子工业中的应用研究。
更新日期:2018-10-16
中文翻译:

外延铁电Hf0.5Zr0.5O2薄膜及其在脑启发计算忆阻器中的实现
具有铁电性的HfO 2掺杂薄膜由于在半导体工业中作为负电容和电阻切换存储器的潜在应用而备受关注。尽管Hf 0.5 Zr 0.5 O 2(HZO)薄膜在所有掺杂的HfO 2中具有最强的铁电性能薄膜,单斜方相HZO薄膜的实现尚未实现,而斜方相HZO的结构-性能关系与铁电之间的直接证据尚未得到证实。在这项工作中,报告了具有适当铁电性和电阻切换行为的单正交相HZO薄膜的生长。借助于先进的结构表征技术,可以确定HZO薄膜处于单斜方晶相。接下来,使用扫描探针显微镜技术和宏观铁电测量,单相HZO薄膜显示出铁电特性,剩余极化约为20 µC cm -2。有趣的是,HZO薄膜显示出具有R的铁电电阻切换OFF / R ON比率约为16 100%,具有出色的器件性能。此外,在HZO薄膜中也观察到了类似大脑的学习行为。这些结果可能有助于刺激HZO薄膜的铁电性能及其在电子工业中的应用研究。











































 京公网安备 11010802027423号
京公网安备 11010802027423号