当前位置:
X-MOL 学术
›
ACS Appl. Electron. Mater.
›
论文详情
Our official English website, www.x-mol.net, welcomes your feedback! (Note: you will need to create a separate account there.)
Transparent Liquid Ag-Based Complex for the Facile Preparation of Robust Sintered Ag Joints in Power Devices
ACS Applied Electronic Materials ( IF 4.7 ) Pub Date : 2024-02-28 , DOI: 10.1021/acsaelm.3c01629 Chuncheng Wang 1, 2 , Hiroaki Tatsumi 2 , Liang Xu 3 , Tao Zhao 3 , Pengli Zhu 3 , Rong Sun 3 , Hiroshi Nishikawa 2
ACS Applied Electronic Materials ( IF 4.7 ) Pub Date : 2024-02-28 , DOI: 10.1021/acsaelm.3c01629 Chuncheng Wang 1, 2 , Hiroaki Tatsumi 2 , Liang Xu 3 , Tao Zhao 3 , Pengli Zhu 3 , Rong Sun 3 , Hiroshi Nishikawa 2
Affiliation
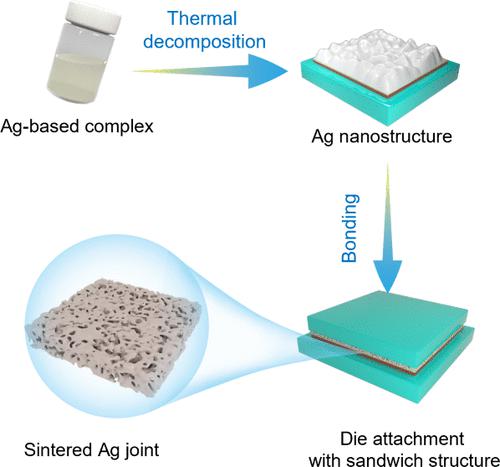
|
Simplifying the bonding technique used to package power devices is crucial for electric vehicles and 5G communication. Herein, a transparent liquid Ag-based complex was employed to simplify the Ag sintering process. The complex can directly fabricate Ag nanostructures on substrates and dies by thermal decomposition at 180 °C for 30 min. These nanostructures consisted of linked nanoparticles with a wide size distribution and exhibited remarkable compressibility, indicating an excellent potential for sintering. Unlike traditional Ag paste, the Ag-based complex presented a single phase, and the obtained Ag nanostructures could be directly sintered at a low temperature. Robust sintered Ag joints with a high average shear strength of 45.4 MPa and a low porosity of 9.3% were successfully achieved by sintering at 300 °C and 5 MPa for 40 min. Such joint properties can be attributed to the frame–filler structure generated during sintering. This structure, which featured large Ag particles acting as frames and small Ag particles acting as bridges linking the frames, was beneficial for improving the sintering performance of the Ag nanostructures. The Ag-based complex could be used for the facile preparation of robust sintered Ag joints, creating possibilities for die attachment while reducing manufacturing costs.
中文翻译:

透明液体银基复合物可轻松制备功率器件中坚固的银烧结接头
简化用于封装功率器件的键合技术对于电动汽车和 5G 通信至关重要。在此,采用透明液体银基复合物来简化银烧结过程。该复合物可以通过在180℃下热分解30分钟,直接在基底和模具上制造银纳米结构。这些纳米结构由具有宽尺寸分布的连接纳米颗粒组成,并表现出显着的可压缩性,表明具有极好的烧结潜力。与传统的银浆料不同,银基复合物呈现单相,并且获得的银纳米结构可以直接在低温下烧结。通过在 300 °C 和 5 MPa 下烧结 40 分钟,成功实现了坚固的烧结银接头,其平均剪切强度高达 45.4 MPa,孔隙率低至 9.3%。这种接头特性可归因于烧结过程中产生的框架-填充结构。这种结构以大银颗粒作为框架,小银颗粒作为连接框架的桥梁,有利于提高银纳米结构的烧结性能。银基复合物可用于轻松制备坚固的烧结银接头,为芯片连接创造可能性,同时降低制造成本。
更新日期:2024-02-28
中文翻译:

透明液体银基复合物可轻松制备功率器件中坚固的银烧结接头
简化用于封装功率器件的键合技术对于电动汽车和 5G 通信至关重要。在此,采用透明液体银基复合物来简化银烧结过程。该复合物可以通过在180℃下热分解30分钟,直接在基底和模具上制造银纳米结构。这些纳米结构由具有宽尺寸分布的连接纳米颗粒组成,并表现出显着的可压缩性,表明具有极好的烧结潜力。与传统的银浆料不同,银基复合物呈现单相,并且获得的银纳米结构可以直接在低温下烧结。通过在 300 °C 和 5 MPa 下烧结 40 分钟,成功实现了坚固的烧结银接头,其平均剪切强度高达 45.4 MPa,孔隙率低至 9.3%。这种接头特性可归因于烧结过程中产生的框架-填充结构。这种结构以大银颗粒作为框架,小银颗粒作为连接框架的桥梁,有利于提高银纳米结构的烧结性能。银基复合物可用于轻松制备坚固的烧结银接头,为芯片连接创造可能性,同时降低制造成本。



























 京公网安备 11010802027423号
京公网安备 11010802027423号