当前位置:
X-MOL 学术
›
Adv. Theory Simul.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Spline-Based Drift Analysis for the Reliability of Semiconductor Devices
Advanced Theory and Simulations ( IF 2.9 ) Pub Date : 2021-07-10 , DOI: 10.1002/adts.202100092 Vera Hofer 1 , Thomas Nowak 1 , Horst Lewitschnig 2
Advanced Theory and Simulations ( IF 2.9 ) Pub Date : 2021-07-10 , DOI: 10.1002/adts.202100092 Vera Hofer 1 , Thomas Nowak 1 , Horst Lewitschnig 2
Affiliation
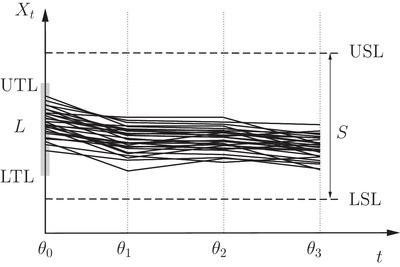
|
Design and production of semiconductor devices for the automotive industry are characterized by high reliability requirements, such that the proper functioning of such devices is ensured over their whole lifetime. Manufacturers subject their products to extensive testing, such as high-temperature operating life (HTOL) tests that simulate the tough requirements products have to withstand. In the present study, the drift behavior of a representative electrical parameter under HTOL stress conditions is modeled, using linear splines, and a model for the determination of test limits used to ensure reliability is formulated. These test limits are computed such that for a predefined probability the electrical parameters under consideration remain within their specification limits over the whole product lifetime. Additionally, the yield loss that might be caused by this quality control procedure should be kept as small as possible. These test limits can then be used by automated test equipment to detect conforming and non-conforming devices immediately after production. Extensive numerical simulations are conducted in order to demonstrate the performance of this model under a wide set of different scenarios for inter- and intra-device variabilities.
中文翻译:

基于样条曲线的半导体器件可靠性漂移分析
用于汽车工业的半导体器件的设计和生产具有高可靠性要求的特点,以确保此类器件在其整个生命周期内都能正常运行。制造商对其产品进行广泛的测试,例如模拟产品必须承受的严苛要求的高温工作寿命 (HTOL) 测试。在本研究中,使用线性样条对 HTOL 应力条件下代表性电气参数的漂移行为进行建模,并制定了用于确定用于确保可靠性的测试限制的模型。这些测试限制的计算方式是,对于预定义的概率,所考虑的电气参数在整个产品生命周期内保持在其规格限制内。此外,这种质量控制程序可能造成的产量损失应尽可能小。然后,自动测试设备可以使用这些测试限制来在生产后立即检测合格和不合格的设备。进行了广泛的数值模拟,以证明该模型在设备间和设备内可变性的广泛不同场景下的性能。
更新日期:2021-08-07
中文翻译:

基于样条曲线的半导体器件可靠性漂移分析
用于汽车工业的半导体器件的设计和生产具有高可靠性要求的特点,以确保此类器件在其整个生命周期内都能正常运行。制造商对其产品进行广泛的测试,例如模拟产品必须承受的严苛要求的高温工作寿命 (HTOL) 测试。在本研究中,使用线性样条对 HTOL 应力条件下代表性电气参数的漂移行为进行建模,并制定了用于确定用于确保可靠性的测试限制的模型。这些测试限制的计算方式是,对于预定义的概率,所考虑的电气参数在整个产品生命周期内保持在其规格限制内。此外,这种质量控制程序可能造成的产量损失应尽可能小。然后,自动测试设备可以使用这些测试限制来在生产后立即检测合格和不合格的设备。进行了广泛的数值模拟,以证明该模型在设备间和设备内可变性的广泛不同场景下的性能。











































 京公网安备 11010802027423号
京公网安备 11010802027423号