Applied Surface Science ( IF 6.7 ) Pub Date : 2021-02-25 , DOI: 10.1016/j.apsusc.2021.149381 Hong Keun Chung , Sung Ok Won , Yongjoo Park , Jin-Sang Kim , Tae Joo Park , Seong Keun Kim
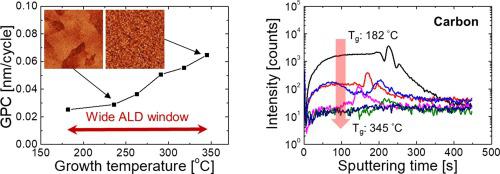
|
Atomic layer deposition (ALD) of TiO2 films from (CpMe5)Ti(OMe)3 as precursor and O3 as co-reactant was examined. The high thermal stability of (CpMe5)Ti(OMe)3 enabled ALD reaction up to a high temperature of 345 °C. A wide temperature window from 182 to 345 °C was achieved in the ALD process, and the growth per cycle increased with increasing the temperature from 0.025 to 0.06 nm/cycle in the ALD window. The impurity content of the films decreased with increasing growth temperature. Above 291 °C, the carbon content in the films decreased to the level in a single crystalline Si substrate. The morphology with patterns spreading radially from the multiple points developed above 236 °C, and the size of the grains decreased as the growth temperature increased. Eventually, a uniform morphology with fine grains was obtained at temperatures > 300 °C. The films grown at the high temperatures exhibited superior dielectric properties. Other common metalorganic precursors of Ti usually restrict the use of high-temperature ALD because they are thermally unstable and decompose below 300 °C. Therefore, (CpMe5)Ti(OMe)3 is favorable for forming dense and high-purity TiO2 films by ALD.
中文翻译:

具有热稳定的(CpMe 5)Ti(OMe)3前体的TiO 2薄膜的原子层沉积
研究了以(CpMe 5)Ti(OMe)3为前驱体和O 3为共反应剂的TiO 2薄膜的原子层沉积(ALD)。(CpMe 5)Ti(OMe)3的高热稳定性使ALD反应温度高达345°C。在ALD过程中,实现了182至345°C的宽温度范围,并且在ALD范围内,随着温度从0.025 nm /周期增加到0.06 nm /周期,每个周期的增长都增加了。薄膜的杂质含量随着生长温度的升高而降低。高于291°C时,薄膜中的碳含量降至单晶Si衬底中的水平。在236°C以上,从多个点开始呈放射状扩展的形态,随着生长温度的升高,晶粒尺寸减小。最终,在> 300°C的温度下获得了具有细晶粒的均匀形态。在高温下生长的膜表现出优异的介电性能。Ti的其他常见金属有机前体通常限制高温ALD的使用,因为它们是热不稳定的,在300°C以下会分解。因此,(CpMe5)Ti(OMe)3有利于通过ALD形成致密,高纯度的TiO 2薄膜。



























 京公网安备 11010802027423号
京公网安备 11010802027423号