Solid-State Electronics ( IF 1.4 ) Pub Date : 2021-02-19 , DOI: 10.1016/j.sse.2021.107979 Tingting Guo , Tingting Tan , Li Duan , Yuxuan Wang , Zizhe Wang
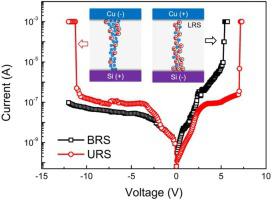
|
Dopants-dependent polarity transition of switching behaviors for HfOx:Cu-based RRAM were investigated. By inducing different concentrations of Cu dopants and setting compliance current, the BRS and URS behaviors of HfOx:Cu films were demonstrated. The chemical bonding states and the doping concentrations of HfOx:Cu films were analyzed by XPS technology. The electroforming processes of BRS and URS behaviors under different polarity of applied voltage were explored to understand the different behaviors of HfOx:Cu films. The uniform distribution of resistances and switching voltages, large memory window and good reliability can be observed for BRS sample. While the excess dopants in the film resulted in the poor reliability of URS sample. The different switching behaviors was closely related to the type and number of defects in the film and their migration may show some effect on multi-level behavior. The switching mechanisms of BRS and URS behaviors of HfOx:Cu films were clarified in the view of oxygen vacancies and Cu ions, and the physical models were proposed.
中文翻译:

基于HfO x的存储器的开关极性取决于掺杂量和电流
研究了基于HfO x:Cu的RRAM的开关行为的掺杂物依赖性极性跃迁。通过诱导不同浓度的Cu掺杂剂并设置顺应性电流,证明了HfO x:Cu膜的BRS和URS行为。用XPS技术分析了HfO x:Cu薄膜的化学键合态和掺杂浓度。探索了在不同施加电压极性下BRS和URS行为的电铸过程,以了解HfO x的不同行为:铜膜 对于BRS样品,可以观察到电阻和开关电压的均匀分布,大的存储窗口和良好的可靠性。薄膜中过量的掺杂剂导致URS样品的可靠性较差。不同的开关行为与薄膜中缺陷的类型和数量密切相关,并且它们的迁移可能对多层行为表现出一定的影响。从氧空位和Cu离子的角度,阐明了HfO x:Cu膜的BRS和URS行为的转换机理,并提出了物理模型。











































 京公网安备 11010802027423号
京公网安备 11010802027423号