当前位置:
X-MOL 学术
›
J. Mater. Chem. C
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Effect of H2S pre-annealing treatment on interfacial and electrical properties of HfO2/Si1−xGex (x = 0–0.3)
Journal of Materials Chemistry C ( IF 5.7 ) Pub Date : 2020-12-29 , DOI: 10.1039/d0tc04760k Woohui Lee 1, 2, 3 , Changmin Lee 1, 2, 3 , Jinyong Kim 1, 2, 3 , Jehoon Lee 1, 2, 3 , Deokjoon Eom 1, 2, 3 , Jae Chan Park 3, 4, 5 , Tae Joo Park 3, 4, 5 , Hyoungsub Kim 1, 2, 3
Journal of Materials Chemistry C ( IF 5.7 ) Pub Date : 2020-12-29 , DOI: 10.1039/d0tc04760k Woohui Lee 1, 2, 3 , Changmin Lee 1, 2, 3 , Jinyong Kim 1, 2, 3 , Jehoon Lee 1, 2, 3 , Deokjoon Eom 1, 2, 3 , Jae Chan Park 3, 4, 5 , Tae Joo Park 3, 4, 5 , Hyoungsub Kim 1, 2, 3
Affiliation
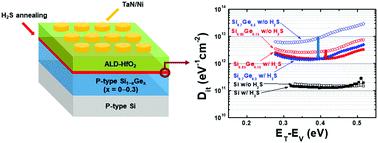
|
To understand the effect of H2S pre-annealing treatment on a Si1−xGex alloy film, the interfacial and electrical characteristics of atomic-layer-deposited HfO2/Si1−xGex were studied while varying the Ge concentration (x value) from 0 to 0.3. H2S pre-annealing was performed on the Si1−xGex substrates at 400 °C for 30 s using a rapid thermal annealing system prior to the HfO2 deposition. As the Ge concentration in Si1−xGex increased, the H2S pretreatment caused a greater increase in the capacitance-equivalent oxide thickness because of accelerated interfacial oxidation by a thermal annealing side effect. However, it was advantageous in reducing the interface state density on a Ge-rich surface, which suggested effective sulfur passivation on the Ge dangling bonds at the HfO2/Si1−xGex interface. Furthermore, the H2S pretreatment was effective in suppressing the out-diffusion of Ge towards the HfO2 film, which was beneficial in improving the near-interface charge trapping characteristics.
中文翻译:

H2S预退火处理对HfO2 / Si1-xGex(x = 0–0.3)的界面和电学性质的影响
为了了解H 2 S预退火处理对Si 1− x Ge x合金膜的影响,研究了在改变Ge浓度的同时沉积原子层的HfO 2 / Si 1− x Ge x的界面和电学特性。(x值)从0到0.3。在HfO 2沉积之前,使用快速热退火系统在400°C的Si 1- x Ge x衬底上进行H 2 S预退火30 s 。随着Si 1- x Ge x中Ge浓度的增加,H 2S预处理由于热退火副作用加速了界面氧化,从而导致等效电容氧化物厚度的更大增加。然而,在降低富含Ge的表面上的界面态密度方面是有利的,这表明在HfO 2 / Si 1- x Ge x界面处的Ge悬挂键上的有效硫钝化。此外,H 2 S预处理有效地抑制了Ge向HfO 2膜的向外扩散,这有利于改善近界面电荷俘获特性。
更新日期:2021-01-14
中文翻译:

H2S预退火处理对HfO2 / Si1-xGex(x = 0–0.3)的界面和电学性质的影响
为了了解H 2 S预退火处理对Si 1− x Ge x合金膜的影响,研究了在改变Ge浓度的同时沉积原子层的HfO 2 / Si 1− x Ge x的界面和电学特性。(x值)从0到0.3。在HfO 2沉积之前,使用快速热退火系统在400°C的Si 1- x Ge x衬底上进行H 2 S预退火30 s 。随着Si 1- x Ge x中Ge浓度的增加,H 2S预处理由于热退火副作用加速了界面氧化,从而导致等效电容氧化物厚度的更大增加。然而,在降低富含Ge的表面上的界面态密度方面是有利的,这表明在HfO 2 / Si 1- x Ge x界面处的Ge悬挂键上的有效硫钝化。此外,H 2 S预处理有效地抑制了Ge向HfO 2膜的向外扩散,这有利于改善近界面电荷俘获特性。









































 京公网安备 11010802027423号
京公网安备 11010802027423号