CIRP Journal of Manufacturing Science and Technology ( IF 4.6 ) Pub Date : 2020-08-22 , DOI: 10.1016/j.cirpj.2020.08.005 Zili Zhang , Zhuji Jin , Jiang Guo
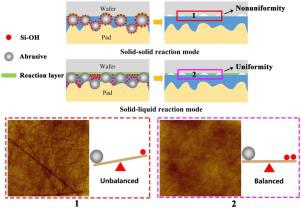
|
Chemical mechanical polishing (CMP) slurries play an important role in the finishing processes of optical components. This paper studies the effect of the interface reaction mode on the polishing performance by comparing the solid–solid and solid–liquid reaction modes. The reason for the different polishing performances of the two reaction modes was elucidated. The results show that balance between the chemical and mechanical effects during CMP can be obtained with the solid–liquid reaction mode. In addition, the solid–liquid reaction mode promotes uniform material removal on the polishing interface. Consequently, micro-scratch generation is avoided, and a good surface finish is obtained with the solid–liquid reaction mode.
中文翻译:

界面反应方式对化学机械抛光的影响
化学机械抛光(CMP)浆料在光学组件的精加工过程中起着重要作用。通过比较固-固和固-液反应模式,研究了界面反应模式对抛光性能的影响。阐明了两种反应模式抛光性能不同的原因。结果表明,固液反应模式可以在CMP过程中获得化学和机械效果之间的平衡。此外,固液反应模式可促进抛光界面上均匀的材料去除。因此,避免了微划痕的产生,并通过固液反应模式获得了良好的表面光洁度。











































 京公网安备 11010802027423号
京公网安备 11010802027423号