Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Study on device reliability for P-type FinFETs with different fin numbers
Vacuum ( IF 3.8 ) Pub Date : 2020-11-01 , DOI: 10.1016/j.vacuum.2020.109601 Yi-Lin Yang , Wenqi Zhang , Shen-Yi Yan , Yin-Hung Yu , Zhen-Yu Fang , Wen-Kuan Yeh
Vacuum ( IF 3.8 ) Pub Date : 2020-11-01 , DOI: 10.1016/j.vacuum.2020.109601 Yi-Lin Yang , Wenqi Zhang , Shen-Yi Yan , Yin-Hung Yu , Zhen-Yu Fang , Wen-Kuan Yeh
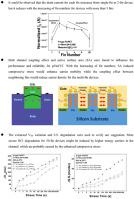
|
Abstract In this work, both channel coupling effect and compressive stress were found to influence the performance and reliability for p-type FinFET. With fin number increasing, the carrier density in the channel is reduced due to the coupling effect between the neighboring fins. On the other hand, with the enlarging of the area of contact etch stop layer (CESL) due to fin number increasing, hole mobility is enhanced because of active surface area (SA) induced compressive stress. As a result, multi-fin FinFET device with more fins shows lower normalized drain current due to reduced carrier density, and worse reliability could also be observed because of hotter carriers in the channel.
中文翻译:

不同鳍片数的P型FinFET器件可靠性研究
摘要 在这项工作中,发现沟道耦合效应和压应力都会影响 p 型 FinFET 的性能和可靠性。随着鳍片数量的增加,由于相邻鳍片之间的耦合效应,沟道中的载流子密度降低。另一方面,随着鳍片数量的增加,接触蚀刻停止层 (CESL) 的面积扩大,由于有源表面积 (SA) 引起的压应力,空穴迁移率增强。因此,由于载流子密度降低,具有更多鳍的多鳍 FinFET 器件显示出较低的归一化漏极电流,并且由于沟道中的载流子较热,还可以观察到更差的可靠性。
更新日期:2020-11-01
中文翻译:

不同鳍片数的P型FinFET器件可靠性研究
摘要 在这项工作中,发现沟道耦合效应和压应力都会影响 p 型 FinFET 的性能和可靠性。随着鳍片数量的增加,由于相邻鳍片之间的耦合效应,沟道中的载流子密度降低。另一方面,随着鳍片数量的增加,接触蚀刻停止层 (CESL) 的面积扩大,由于有源表面积 (SA) 引起的压应力,空穴迁移率增强。因此,由于载流子密度降低,具有更多鳍的多鳍 FinFET 器件显示出较低的归一化漏极电流,并且由于沟道中的载流子较热,还可以观察到更差的可靠性。











































 京公网安备 11010802027423号
京公网安备 11010802027423号