当前位置:
X-MOL 学术
›
Phys. Status Solidi. Rapid Res. Lett.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Integration of Dielectric and Ferroelectric Hafnium Aluminum Oxides for Thin‐Film Transistor Applications
Physica Status Solidi-Rapid Research Letters ( IF 2.5 ) Pub Date : 2020-07-10 , DOI: 10.1002/pssr.202000258 Hsiao-Hsuan Hsu, Sheng Lee, Hsiu-Ming Liu
Physica Status Solidi-Rapid Research Letters ( IF 2.5 ) Pub Date : 2020-07-10 , DOI: 10.1002/pssr.202000258 Hsiao-Hsuan Hsu, Sheng Lee, Hsiu-Ming Liu
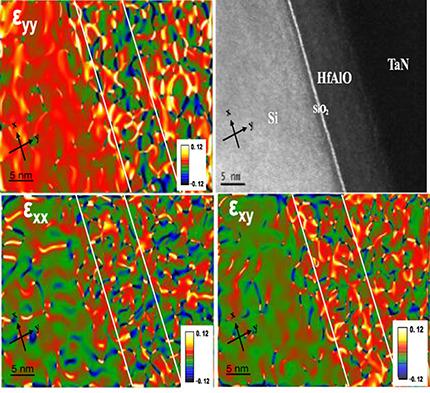
|
Herein, the integration of dielectric and ferroelectric HfAlOx within a one‐transistor and one‐capacitor thin‐film transistor (TFT)‐based device structure is successfully demonstrated. It is found that the origin of gate stress for enhancing ferroelectricity is mainly ascribed to nonlinear thermal stress distribution, and the ferroelectricity of HfAlOx is further improved by nitrogen plasma treatment without sacrificing leakage current during post metal annealing. Notably, the p‐type SnO TFT in series with a ferroelectric HfAlOx capacitor with nitrogen plasma treatment achieves an almost 43% improvement on threshold voltage shift (5.45 V) at a low operating voltage of 3 V. Therefore, the ferroelectric nitridation treatment not only strengthens the ferroelectric domain switching of HfAlOx but also improves capacitance matching with the HfAlOx dielectric layer of p‐type SnO TFT.
中文翻译:

用于薄膜晶体管应用的介电和铁电Ha氧化铝的集成
在本文中,成功地证明了基于单晶体管和单电容器薄膜晶体管(TFT)的器件结构中电介质和铁电HfAlO x的集成。发现用于增强铁电的栅极应力的起源主要归因于非线性热应力分布,并且通过氮等离子体处理在不牺牲后金属退火期间的漏电流的情况下进一步改善了HfAlO x的铁电。值得注意的是,p型SnO TFT与铁电HfAlO x串联在3 V的低工作电压下,经过氮等离子体处理的电容器在阈值电压偏移(5.45 V)上几乎提高了43%。因此,铁电氮化处理不仅增强了HfAlO x的铁电畴切换,而且还改善了与p型SnO TFT的HfAlO x介电层。
更新日期:2020-07-10
中文翻译:

用于薄膜晶体管应用的介电和铁电Ha氧化铝的集成
在本文中,成功地证明了基于单晶体管和单电容器薄膜晶体管(TFT)的器件结构中电介质和铁电HfAlO x的集成。发现用于增强铁电的栅极应力的起源主要归因于非线性热应力分布,并且通过氮等离子体处理在不牺牲后金属退火期间的漏电流的情况下进一步改善了HfAlO x的铁电。值得注意的是,p型SnO TFT与铁电HfAlO x串联在3 V的低工作电压下,经过氮等离子体处理的电容器在阈值电压偏移(5.45 V)上几乎提高了43%。因此,铁电氮化处理不仅增强了HfAlO x的铁电畴切换,而且还改善了与p型SnO TFT的HfAlO x介电层。











































 京公网安备 11010802027423号
京公网安备 11010802027423号