当前位置:
X-MOL 学术
›
Phys. Status Solidi A
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Single Ion Implantation of Bismuth
Physica Status Solidi (A) - Applications and Materials Science Pub Date : 2020-07-02 , DOI: 10.1002/pssa.202000237 Nathan Cassidy 1 , Paul Blenkinsopp 2 , Ian Brown 2 , Richard J. Curry 3 , B. N. Murdin 4 , Roger Webb 1 , David Cox 4
Physica Status Solidi (A) - Applications and Materials Science Pub Date : 2020-07-02 , DOI: 10.1002/pssa.202000237 Nathan Cassidy 1 , Paul Blenkinsopp 2 , Ian Brown 2 , Richard J. Curry 3 , B. N. Murdin 4 , Roger Webb 1 , David Cox 4
Affiliation
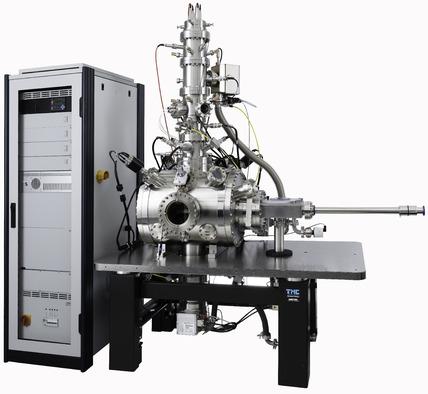
|
Herein, the results from a focused ion beam instrument, designed to implant single ions with a view to the fabrication of qubits for quantum technologies, are presented. The difficulty of single ion implantation is accurately counting the ion impacts. This is achieved here through the detection of secondary electrons generated upon each ion impact. The implantation of single bismuth ions with different charge states into Si, Ge, Cu, and Au substrates is reported, and the counting detection efficiency for single ion implants and the factors that affect such detection efficiencies are determined. It is found that for 50 keV implants of Bi++ ions into silicon an 89% detection efficiency can be achieved, which is the first quantitative detection efficiency measurement for single ion implants into silicon without implanting through a thick SiO2 film. This level of counting accuracy provides implantation of single impurity ions with a success rate significantly exceeding that achievable by random (Poissonian) implantation.
中文翻译:

铋的单离子注入
本文介绍了聚焦离子束仪的结果,该离子束仪旨在注入单个离子,以制造量子技术用量子位。单离子注入的困难在于准确地计算离子的影响。在这里,这是通过检测每次离子撞击产生的二次电子来实现的。报道了将具有不同电荷状态的单铋离子注入到Si,Ge,Cu和Au衬底中,并确定了单离子注入的计数检测效率以及影响这种检测效率的因素。发现对于Bi ++的50 keV植入物离子进入硅的检测效率可达到89%,这是对单个离子注入硅而无需通过厚SiO 2膜进行注入的首次定量检测效率测量。此计数精度水平提供了单个杂质离子的注入,其成功率大大超过了随机(泊松)注入可获得的成功率。
更新日期:2020-07-02
中文翻译:

铋的单离子注入
本文介绍了聚焦离子束仪的结果,该离子束仪旨在注入单个离子,以制造量子技术用量子位。单离子注入的困难在于准确地计算离子的影响。在这里,这是通过检测每次离子撞击产生的二次电子来实现的。报道了将具有不同电荷状态的单铋离子注入到Si,Ge,Cu和Au衬底中,并确定了单离子注入的计数检测效率以及影响这种检测效率的因素。发现对于Bi ++的50 keV植入物离子进入硅的检测效率可达到89%,这是对单个离子注入硅而无需通过厚SiO 2膜进行注入的首次定量检测效率测量。此计数精度水平提供了单个杂质离子的注入,其成功率大大超过了随机(泊松)注入可获得的成功率。











































 京公网安备 11010802027423号
京公网安备 11010802027423号