当前位置:
X-MOL 学术
›
Microelectron. Reliab.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Research of single-event burnout and hardened GaN MISFET with embedded PN junction
Microelectronics Reliability ( IF 1.6 ) Pub Date : 2020-07-01 , DOI: 10.1016/j.microrel.2020.113699 Xin-Xing Fei , Ying Wang , Xin Luo , Meng-Tian Bao , Cheng-Hao Yu , Xing-Ji Li
Microelectronics Reliability ( IF 1.6 ) Pub Date : 2020-07-01 , DOI: 10.1016/j.microrel.2020.113699 Xin-Xing Fei , Ying Wang , Xin Luo , Meng-Tian Bao , Cheng-Hao Yu , Xing-Ji Li
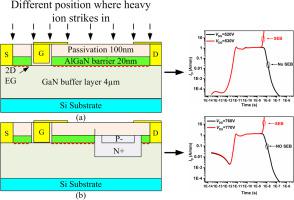
|
Abstract This paper describes a single-event burnout (SEB) simulation for a conventional GaN MISFET field plate (FPC-MISFET) and a MISFET with an embedded pn junction (EJ-MISFET). The SEB triggering mechanism is affected by impact ionization. The electrons, which are induced by heavy ion exposure, can rapidly move to the drain, which leads to strong impact ionization around the drain. Compared to the FPC-MISFET, both the peak electric field and the impact ionization around the drain are reduced in the GaN MISFET with the embedded pn junction. The proposed EJ-MISFET also shows improved SEB performance. For a heavy ion, with a linear energy transfer (LET) of 0.6 pC/μm (hitting the devices) vertically, the SEB threshold voltages for the FPC-MISFET and EJ-MISFET are 520 and 760 V, respectively.
中文翻译:

嵌入式PN结单粒子烧毁硬化GaN MISFET的研究
摘要 本文描述了传统 GaN MISFET 场板 (FPC-MISFET) 和具有嵌入式 pn 结的 MISFET (EJ-MISFET) 的单事件烧毁 (SEB) 仿真。SEB 触发机制受碰撞电离的影响。由重离子暴露引起的电子可以快速移动到漏极,这导致漏极周围的强烈碰撞电离。与 FPC-MISFET 相比,在具有嵌入式 pn 结的 GaN MISFET 中,峰值电场和漏极周围的碰撞电离都降低了。提议的 EJ-MISFET 还显示出改进的 SEB 性能。对于重离子,垂直线性能量转移 (LET) 为 0.6 pC/μm(击中器件),FPC-MISFET 和 EJ-MISFET 的 SEB 阈值电压分别为 520 V 和 760 V。
更新日期:2020-07-01
中文翻译:

嵌入式PN结单粒子烧毁硬化GaN MISFET的研究
摘要 本文描述了传统 GaN MISFET 场板 (FPC-MISFET) 和具有嵌入式 pn 结的 MISFET (EJ-MISFET) 的单事件烧毁 (SEB) 仿真。SEB 触发机制受碰撞电离的影响。由重离子暴露引起的电子可以快速移动到漏极,这导致漏极周围的强烈碰撞电离。与 FPC-MISFET 相比,在具有嵌入式 pn 结的 GaN MISFET 中,峰值电场和漏极周围的碰撞电离都降低了。提议的 EJ-MISFET 还显示出改进的 SEB 性能。对于重离子,垂直线性能量转移 (LET) 为 0.6 pC/μm(击中器件),FPC-MISFET 和 EJ-MISFET 的 SEB 阈值电压分别为 520 V 和 760 V。











































 京公网安备 11010802027423号
京公网安备 11010802027423号