当前位置:
X-MOL 学术
›
ACS Appl. Electron. Mater.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Atomic Layer Densification of AlN Passivation Layer on Epitaxial Ge for Enhancement of Reliability and Electrical Performance of High-K Gate Stacks
ACS Applied Electronic Materials ( IF 4.3 ) Pub Date : 2020-03-24 , DOI: 10.1021/acsaelm.9b00819 Chin-I Wang, Teng-Jan Chang, Yu-Tung Yin, Yu-Sen Jiang, Jing-Jong Shyue, Miin-Jang Chen
ACS Applied Electronic Materials ( IF 4.3 ) Pub Date : 2020-03-24 , DOI: 10.1021/acsaelm.9b00819 Chin-I Wang, Teng-Jan Chang, Yu-Tung Yin, Yu-Sen Jiang, Jing-Jong Shyue, Miin-Jang Chen
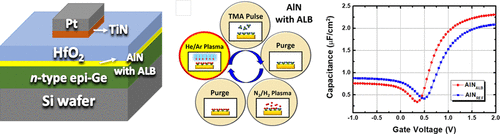
|
The impact of atomic layer bombardment (ALB) on the aluminum nitride (AlN) passivation layer between the HfO2 gate dielectric and the n-type epitaxial germanium (Ge) was investigated. The ALB technique was performed with the layer-by-layer, in situ helium/argon plasma bombardment in each cycle of atomic layer deposition (ALD) of AlN. An increase in the film density and a decrease in nitrogen vacancies, as manifested by the X-ray reflection and X-ray spectroscopy, were observed in the AlN layer treated by the ALB process. The improvements in the AlN quality contribute to a reduction of the equivalent oxide thickness from 1.36 to 1.19 nm of the AlN/HfO2 gate stack, together with the suppression of the gate leakage current, the interfacial state density, and the slow trap density. The reliability tests reveal promising reliability of the AlN/HfO2 gate stack with a small flat-band voltage shift under the constant voltage stress and a high operation voltage of ∼2.4 V projected for a 10 years time-dependent-dielectric-breakdown lifetime. All of the results point that the ALB technique can effectively enhance the material/interface properties, electrical characteristics, and reliability of nanoscale devices, which is critical and beneficial to the next-generation high-speed and low-power nanoelectronics.
中文翻译:

外延Ge上AlN钝化层的原子层致密化,以增强高K栅堆叠的可靠性和电性能
研究了原子层轰击(ALB)对HfO 2栅极电介质和n型外延锗(Ge)之间的氮化铝(AlN)钝化层的影响。ALB技术是在AlN原子层沉积(ALD)的每个循环中,逐层进行原位氦/氩等离子体轰击。在通过ALB工艺处理的AlN层中,观察到膜密度的增加和氮空位的减少,如通过X射线反射和X射线光谱学所证明的。AlN质量的提高有助于将AlN / HfO 2的等效氧化物厚度从1.36 nm降低到1.19 nm栅堆叠,以及对栅漏电流,界面态密度和慢陷阱能级的抑制。可靠性测试表明,AlN / HfO 2栅堆叠具有可观的可靠性,在恒定电压应力下具有较小的平带电压偏移,并且预计在10年内具有与时间相关的介电击穿寿命,其工作电压约为2.4V。所有结果都表明,ALB技术可以有效地增强纳米级器件的材料/界面特性,电学特性和可靠性,这对于下一代高速和低功率纳米电子学来说至关重要。
更新日期:2020-03-24
中文翻译:

外延Ge上AlN钝化层的原子层致密化,以增强高K栅堆叠的可靠性和电性能
研究了原子层轰击(ALB)对HfO 2栅极电介质和n型外延锗(Ge)之间的氮化铝(AlN)钝化层的影响。ALB技术是在AlN原子层沉积(ALD)的每个循环中,逐层进行原位氦/氩等离子体轰击。在通过ALB工艺处理的AlN层中,观察到膜密度的增加和氮空位的减少,如通过X射线反射和X射线光谱学所证明的。AlN质量的提高有助于将AlN / HfO 2的等效氧化物厚度从1.36 nm降低到1.19 nm栅堆叠,以及对栅漏电流,界面态密度和慢陷阱能级的抑制。可靠性测试表明,AlN / HfO 2栅堆叠具有可观的可靠性,在恒定电压应力下具有较小的平带电压偏移,并且预计在10年内具有与时间相关的介电击穿寿命,其工作电压约为2.4V。所有结果都表明,ALB技术可以有效地增强纳米级器件的材料/界面特性,电学特性和可靠性,这对于下一代高速和低功率纳米电子学来说至关重要。











































 京公网安备 11010802027423号
京公网安备 11010802027423号