当前位置:
X-MOL 学术
›
Scr. Mater.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Die-attach bonding for high temperature applications using thermal decomposition of copper(II) formate with polyethylene glycol
Scripta Materialia ( IF 5.3 ) Pub Date : 2020-06-01 , DOI: 10.1016/j.scriptamat.2020.02.045 Sri Krishna Bhogaraju , Omid Mokhtari , Fosca Conti , Gordon Elger
Scripta Materialia ( IF 5.3 ) Pub Date : 2020-06-01 , DOI: 10.1016/j.scriptamat.2020.02.045 Sri Krishna Bhogaraju , Omid Mokhtari , Fosca Conti , Gordon Elger
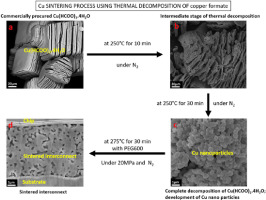
|
Abstract A copper paste based on commercial available copper(II) formate microparticles and polyethylene glycol as binder has been developed for bonding of semiconductor dies onto substrates below 300 °C. Thermal decomposition of copper(II) formate leads to the formation of copper nanoparticles, which are used to connect the chip electrically and mechanically to the substrate by a sinter process. The binder provides printability of the paste, protects the copper particles from oxidation and supports the formation of fine copper nanoparticles. Shear tests of the sintered interconnects return shear strength values of 60 MPa, offering a promising solution to form pure copper interconnects.
中文翻译:

使用聚乙二醇热分解甲酸铜 (II) 用于高温应用的芯片粘接
摘要 基于市售的甲酸铜 (II) 微粒和聚乙二醇作为粘合剂开发了一种铜膏,用于在 300 °C 以下将半导体芯片粘合到基板上。甲酸铜 (II) 的热分解导致形成铜纳米颗粒,铜纳米颗粒用于通过烧结工艺将芯片电气和机械连接到基板。粘合剂提供浆料的可印刷性,保护铜颗粒免受氧化并支持细铜纳米颗粒的形成。烧结互连的剪切测试返回 60 MPa 的剪切强度值,为形成纯铜互连提供了有前途的解决方案。
更新日期:2020-06-01
中文翻译:

使用聚乙二醇热分解甲酸铜 (II) 用于高温应用的芯片粘接
摘要 基于市售的甲酸铜 (II) 微粒和聚乙二醇作为粘合剂开发了一种铜膏,用于在 300 °C 以下将半导体芯片粘合到基板上。甲酸铜 (II) 的热分解导致形成铜纳米颗粒,铜纳米颗粒用于通过烧结工艺将芯片电气和机械连接到基板。粘合剂提供浆料的可印刷性,保护铜颗粒免受氧化并支持细铜纳米颗粒的形成。烧结互连的剪切测试返回 60 MPa 的剪切强度值,为形成纯铜互连提供了有前途的解决方案。










































 京公网安备 11010802027423号
京公网安备 11010802027423号