当前位置:
X-MOL 学术
›
Plasma Processes Polym.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
The effect of pretreatment for SiH4 gas by microwave plasma on Si film formation behavior by thermal CVD
Plasma Processes and Polymers ( IF 2.9 ) Pub Date : 2020-01-27 , DOI: 10.1002/ppap.201900198 Keiichi Hamanaka 1 , Norihisa Takei 1 , Hiroaki Kakiuchi 1 , Kiyoshi Yasutake 1, 2 , Hiromasa Ohmi 1, 2
Plasma Processes and Polymers ( IF 2.9 ) Pub Date : 2020-01-27 , DOI: 10.1002/ppap.201900198 Keiichi Hamanaka 1 , Norihisa Takei 1 , Hiroaki Kakiuchi 1 , Kiyoshi Yasutake 1, 2 , Hiromasa Ohmi 1, 2
Affiliation
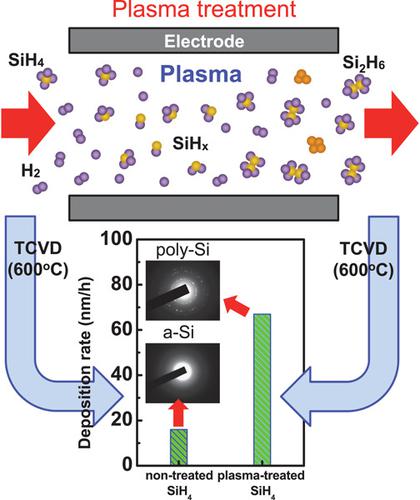
|
We propose a pretreatment method for monosilane (SiH4) gas by high‐density plasma toward the relatively low‐temperature formation (≤600°C) of a crystalline Si film by thermal chemical vapor deposition (TCVD). SiH4 reaction behaviors with the plasma are investigated by using gas‐phase Fourier‐transform infrared spectroscopy. The dependence of the Si2H6 formation characteristics on total gas flow rate and input microwave power is examined. Si2H6 gas yields with the plasma treatment for SiH4 gas increased with decreasing input microwave power and increased with increasing total gas flow rate. Si films are prepared by TCVD using the plasma‐treated SiH4 gas. As a result, the pretreatment for SiH4 gas by high‐density plasma affects not only the deposition rate but also the crystallinity of the obtained Si film. The mechanism by which Si film formation is improved by plasma treatment is discussed.
中文翻译:

微波等离子体预处理SiH4气体对热CVD硅膜形成行为的影响
我们提出了一种通过高密度等离子体对甲硅烷(SiH 4)气体进行预处理的方法,该方法是通过热化学气相沉积(TCVD)在较低温度下形成结晶硅膜(≤600°C)。通过气相傅立叶变换红外光谱研究了SiH 4与等离子体的反应行为。研究了Si 2 H 6形成特性对总气体流量和输入微波功率的依赖性。等离子体处理的SiH 4气体的Si 2 H 6气体产率随着输入微波功率的降低而增加,并随着总气体流速的增加而增加。使用等离子处理的SiH通过TCVD制备Si膜4气。结果,高密度等离子体对SiH 4气体的预处理不仅影响沉积速率,而且影响所得Si膜的结晶度。讨论了通过等离子体处理改善硅膜形成的机理。
更新日期:2020-01-27
中文翻译:

微波等离子体预处理SiH4气体对热CVD硅膜形成行为的影响
我们提出了一种通过高密度等离子体对甲硅烷(SiH 4)气体进行预处理的方法,该方法是通过热化学气相沉积(TCVD)在较低温度下形成结晶硅膜(≤600°C)。通过气相傅立叶变换红外光谱研究了SiH 4与等离子体的反应行为。研究了Si 2 H 6形成特性对总气体流量和输入微波功率的依赖性。等离子体处理的SiH 4气体的Si 2 H 6气体产率随着输入微波功率的降低而增加,并随着总气体流速的增加而增加。使用等离子处理的SiH通过TCVD制备Si膜4气。结果,高密度等离子体对SiH 4气体的预处理不仅影响沉积速率,而且影响所得Si膜的结晶度。讨论了通过等离子体处理改善硅膜形成的机理。











































 京公网安备 11010802027423号
京公网安备 11010802027423号