当前位置:
X-MOL 学术
›
Soft Matter
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Nano-confinement of block copolymers in high accuracy topographical guiding patterns: modelling the emergence of defectivity due to incommensurability†
Soft Matter ( IF 2.9 ) Pub Date : 2018-07-05 00:00:00 , DOI: 10.1039/c8sm01045e Steven Gottlieb 1, 2, 3, 4 , Dimitrios Kazazis 5, 6, 7, 8 , Iacopo Mochi 5, 6, 7, 8 , Laura Evangelio 1, 2, 3, 4 , Marta Fernández-Regúlez 1, 2, 3, 4 , Yasin Ekinci 5, 6, 7, 8 , Francesc Perez-Murano 1, 2, 3, 4
Soft Matter ( IF 2.9 ) Pub Date : 2018-07-05 00:00:00 , DOI: 10.1039/c8sm01045e Steven Gottlieb 1, 2, 3, 4 , Dimitrios Kazazis 5, 6, 7, 8 , Iacopo Mochi 5, 6, 7, 8 , Laura Evangelio 1, 2, 3, 4 , Marta Fernández-Regúlez 1, 2, 3, 4 , Yasin Ekinci 5, 6, 7, 8 , Francesc Perez-Murano 1, 2, 3, 4
Affiliation
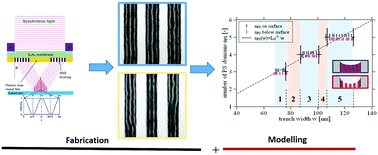
|
Extreme ultraviolet interference lithography (EUV-IL) is used to manufacture topographical guiding patterns to direct the self-assembly of block copolymers. High-accuracy silicon oxide-like patterns with trenches ranging from 68 nm to 117 nm width are fabricated by exposing a hydrogen silsesquioxane (HSQ) resist layer using EUV-IL. We investigate how the accuracy, the low line width roughness and the low line edge roughness of the resulting patterns allow achieving DSA line/space patterns of a PS-b-PMMA (polystyrene-block-poly methyl methacrylate) block copolymer of 11 nm half-pitch with low defectivity. We conduct an in-depth study of the dependence of the DSA pattern morphology on the trench width and on how the neutral brush covers the guiding pattern. We identify the relation between trench width and the emergence of defects with nanometer precision. Based on these studies, we develop a model that extends available free energy models, which allows us to predict the patterning process window.
中文翻译:

以高精度的地形引导图案对嵌段共聚物进行纳米约束:模拟由于不可通约性而导致缺陷的出现†
极紫外干涉光刻(EUV-IL)用于制造形貌引导图案,以指导嵌段共聚物的自组装。通过使用EUV-IL曝光氢倍半硅氧烷(HSQ)抗蚀剂层来制作沟槽宽度在68 nm至117 nm范围内的高精度类氧化硅图形。我们研究了所得图案的精度,低线宽粗糙度和低线边缘粗糙度如何实现PS- b -PMMA(聚苯乙烯嵌段)的DSA线/空间图案-低缺陷度的11纳米半节距的聚(甲基丙烯酸甲酯)嵌段共聚物。我们对DSA图案形态对沟槽宽度的依赖性以及中性笔刷如何覆盖引导图案进行了深入研究。我们以纳米精度确定了沟槽宽度与缺陷的出现之间的关系。基于这些研究,我们开发了一个扩展可用自由能模型的模型,该模型使我们能够预测构图过程窗口。
更新日期:2018-07-05
中文翻译:

以高精度的地形引导图案对嵌段共聚物进行纳米约束:模拟由于不可通约性而导致缺陷的出现†
极紫外干涉光刻(EUV-IL)用于制造形貌引导图案,以指导嵌段共聚物的自组装。通过使用EUV-IL曝光氢倍半硅氧烷(HSQ)抗蚀剂层来制作沟槽宽度在68 nm至117 nm范围内的高精度类氧化硅图形。我们研究了所得图案的精度,低线宽粗糙度和低线边缘粗糙度如何实现PS- b -PMMA(聚苯乙烯嵌段)的DSA线/空间图案-低缺陷度的11纳米半节距的聚(甲基丙烯酸甲酯)嵌段共聚物。我们对DSA图案形态对沟槽宽度的依赖性以及中性笔刷如何覆盖引导图案进行了深入研究。我们以纳米精度确定了沟槽宽度与缺陷的出现之间的关系。基于这些研究,我们开发了一个扩展可用自由能模型的模型,该模型使我们能够预测构图过程窗口。











































 京公网安备 11010802027423号
京公网安备 11010802027423号