当前位置:
X-MOL 学术
›
Mol. Syst. Des. Eng.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Healing surface roughness of lithographic nanopatterns through sub-10 nm aqueous-dispersible polymeric particles with excellent dry etch durability†
Molecular Systems Design & Engineering ( IF 3.2 ) Pub Date : 2018-04-30 00:00:00 , DOI: 10.1039/c8me00007g Zhen Jiang 1, 2, 3, 4, 5 , Han-Hao Cheng 2, 3, 4, 6 , Idriss Blakey 1, 2, 3, 4, 7 , Andrew K. Whittaker 1, 2, 3, 4, 5
Molecular Systems Design & Engineering ( IF 3.2 ) Pub Date : 2018-04-30 00:00:00 , DOI: 10.1039/c8me00007g Zhen Jiang 1, 2, 3, 4, 5 , Han-Hao Cheng 2, 3, 4, 6 , Idriss Blakey 1, 2, 3, 4, 7 , Andrew K. Whittaker 1, 2, 3, 4, 5
Affiliation
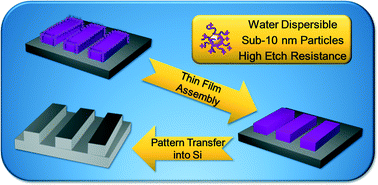
|
The surface roughness in patterned features, commonly termed line-edge roughness (LER), is of particular concern in the manufacture of advanced micro-electronics devices. To address this challenge, we describe an approach whereby the block copolymer poly(oligoethyleneglycol methyl ether methacrylate-stat-styrene)-b-P(N-[3-(dimethylamino)propyl]methacrylamide) (poly(OEGMA-stat-styrene)-b-PDMAPMA) is applied to the patterned photoresist, and after thermal annealing reduces significantly the nanoscale surface roughness. The incorporation of hydrophilic OEGMA units enabled the block polymer to be readily dispersed in water and to self-assemble into particles of less than 10 nm in diameter. Importantly, as a result of the incorporation of a relatively high content of the monomer styrene, excellent plasma etch durability was achieved. The relatively low glass transition temperature of the block copolymer allows thermal annealing at temperatures well below the Tg of the photoresist, enabling effective reduction in LER with minimal change to the profiles of the resist sidewalls and trenches. Partial healing of roughness in lithographic patterns with critical dimensions as low as 25 nm was demonstrated. Finally the relatively high aromatic content of the block copolymer allowed the smoothed patterns to be successfully transferred into the underlying silicon wafer.
中文翻译:

通过低于10 nm的水分散性聚合物颗粒可修复平版印刷纳米图案的表面粗糙度,并具有出色的干法蚀刻耐久性†
图案化特征中的表面粗糙度(通常称为线边缘粗糙度(LER))在先进微电子器件的制造中尤为重要。为了应对这一挑战,我们描述了一种方法,由此所述嵌段共聚物的聚(oligoethyleneglycol甲基醚丙烯酸甲酯- STAT -苯乙烯) - BP(ñ - [3-(二甲基氨基)丙基]甲基丙烯酰胺)(聚(OEGMA- STAT -苯乙烯) - b-PDMAPMA)应用于图案化的光致抗蚀剂,并且在热退火之后,纳米级表面粗糙度显着降低。亲水性OEGMA单元的结合使嵌段聚合物易于分散在水中,并自组装成直径小于10 nm的颗粒。重要的是,由于掺入了相对较高含量的单体苯乙烯,因此获得了优异的等离子体蚀刻耐久性。嵌段共聚物的较低的玻璃化转变温度允许在远低于T g的温度下进行热退火。可以在光刻胶侧壁和沟槽的轮廓变化最小的情况下有效降低LER。在临界尺寸低至25 nm的光刻图案中,粗糙度得到部分修复。最终,嵌段共聚物的相对较高的芳族含量允许将平滑的图案成功地转移到下面的硅晶片中。
更新日期:2018-04-30
中文翻译:

通过低于10 nm的水分散性聚合物颗粒可修复平版印刷纳米图案的表面粗糙度,并具有出色的干法蚀刻耐久性†
图案化特征中的表面粗糙度(通常称为线边缘粗糙度(LER))在先进微电子器件的制造中尤为重要。为了应对这一挑战,我们描述了一种方法,由此所述嵌段共聚物的聚(oligoethyleneglycol甲基醚丙烯酸甲酯- STAT -苯乙烯) - BP(ñ - [3-(二甲基氨基)丙基]甲基丙烯酰胺)(聚(OEGMA- STAT -苯乙烯) - b-PDMAPMA)应用于图案化的光致抗蚀剂,并且在热退火之后,纳米级表面粗糙度显着降低。亲水性OEGMA单元的结合使嵌段聚合物易于分散在水中,并自组装成直径小于10 nm的颗粒。重要的是,由于掺入了相对较高含量的单体苯乙烯,因此获得了优异的等离子体蚀刻耐久性。嵌段共聚物的较低的玻璃化转变温度允许在远低于T g的温度下进行热退火。可以在光刻胶侧壁和沟槽的轮廓变化最小的情况下有效降低LER。在临界尺寸低至25 nm的光刻图案中,粗糙度得到部分修复。最终,嵌段共聚物的相对较高的芳族含量允许将平滑的图案成功地转移到下面的硅晶片中。









































 京公网安备 11010802027423号
京公网安备 11010802027423号