Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Vacuum Ultraviolet Treatment of Acid- and Ester-Terminated Self-Assembled Monolayers: Chemical Conversions and Friction Reduction
Langmuir ( IF 3.7 ) Pub Date : 2018-02-16 00:00:00 , DOI: 10.1021/acs.langmuir.7b04327 Ahmed I. A. Soliman 1 , Toru Utsunomiya 1 , Takashi Ichii 1 , Hiroyuki Sugimura 1
Langmuir ( IF 3.7 ) Pub Date : 2018-02-16 00:00:00 , DOI: 10.1021/acs.langmuir.7b04327 Ahmed I. A. Soliman 1 , Toru Utsunomiya 1 , Takashi Ichii 1 , Hiroyuki Sugimura 1
Affiliation
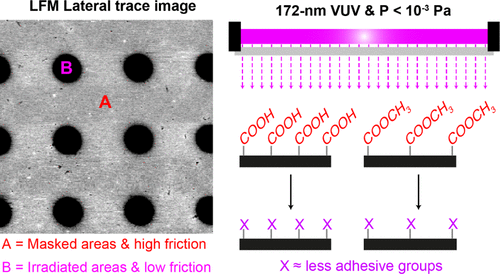
|
We have prepared COOH- and COOCH3-terminated self-assembled monolayers (SAMs) from undec-10-enoic acid (UDA) and methyl undec-10-enoate (MUDO) molecules on hydrogen-terminated silicon (H–Si) substrates through ultraviolet (UV) irradiation. The as-prepared UDA- and MUDO-SAMs were exposed to 172 nm vacuum-UV (VUV) light in a high vacuum environment (HV, <10–3 Pa) for different periods. The presence of COO components at the surfaces of these SAMs without prior oxidation would simplify the understanding of the origin of the chemical conversions and the changes of surface properties, as the prior oxidation would change the surface properties and generate different oxygenated groups. After the HV-VUV treatment, the abundance of COOH and COOCH3 components of these SAMs decreased without significant dissociation of their C–C backbones. Degradation of these components occurred through dissociating their C–O bonds, resulting in different C═O components. Also, the occurrence of Norrish type pathways resulted in a slight decrease of carbon content and produced CH3 components. We have applied the HV-VUV lithography to control the abundance of COOH and COOCH3 components in well-defined areas and to investigate the friction differences between the irradiated and masked areas. The irradiated areas exhibited lower friction than the masked areas without observing significant height contrasts between these areas. The reduction in friction was attributed to the conversion of the COOH and COOCH3 components to less adhesive components such as C═O and CH3. These experiments suggest the HV-VUV treatments as an approach for low damage dry surface modifications and reductive lithographic techniques at surfaces terminated by acid and ester groups.
中文翻译:

酸和酯封端的自组装单分子膜的真空紫外线处理:化学转化和减摩
我们已经通过氢封端的硅(H-Si)衬底上的十一碳烯酸(UDA)和十一碳烯酸甲酯(MUDO)分子,通过十一碳烯酸(UDA)和十一碳烯酸甲酯(MUDO)分子制备了由COOH和COOCH 3终止的自组装单层膜(SAMs)紫外线(UV)照射。将准备好的UDA和MUDO-SAM在高真空环境(HV,<10 –3 Pa)中暴露于172 nm真空UV(VUV)光中不同的时间。在没有预先氧化的情况下,在这些SAM的表面存在COO成分将简化对化学转化的起源和表面性质变化的理解,因为先前的氧化会改变表面性质并生成不同的氧化基团。HV-VUV处理后,COOH和COOCH 3的含量很高这些SAM的组成部分减少了,而C–C主链没有明显分离。这些成分的降解通过解离它们的C–O键而发生,从而导致不同的C═O成分。此外,诺里什型途径的出现导致碳含量略有下降并产生了CH 3组分。我们已经应用了HV-VUV光刻技术来控制定义明确区域中的COOH和COOCH 3组分的丰度,并研究了受辐照和遮蔽区域之间的摩擦差异。被辐照的区域显示出的摩擦力比被遮盖的区域要低,而没有观察到这些区域之间的明显的高度对比。摩擦的减少归因于COOH和COOCH 3的转化成分较少的粘合成分,例如C = O和CH 3。这些实验表明,HV-VUV处理可作为在受到酸和酯基终止的表面上进行低损伤干表面改性和还原性光刻技术的方法。
更新日期:2018-02-16
中文翻译:

酸和酯封端的自组装单分子膜的真空紫外线处理:化学转化和减摩
我们已经通过氢封端的硅(H-Si)衬底上的十一碳烯酸(UDA)和十一碳烯酸甲酯(MUDO)分子,通过十一碳烯酸(UDA)和十一碳烯酸甲酯(MUDO)分子制备了由COOH和COOCH 3终止的自组装单层膜(SAMs)紫外线(UV)照射。将准备好的UDA和MUDO-SAM在高真空环境(HV,<10 –3 Pa)中暴露于172 nm真空UV(VUV)光中不同的时间。在没有预先氧化的情况下,在这些SAM的表面存在COO成分将简化对化学转化的起源和表面性质变化的理解,因为先前的氧化会改变表面性质并生成不同的氧化基团。HV-VUV处理后,COOH和COOCH 3的含量很高这些SAM的组成部分减少了,而C–C主链没有明显分离。这些成分的降解通过解离它们的C–O键而发生,从而导致不同的C═O成分。此外,诺里什型途径的出现导致碳含量略有下降并产生了CH 3组分。我们已经应用了HV-VUV光刻技术来控制定义明确区域中的COOH和COOCH 3组分的丰度,并研究了受辐照和遮蔽区域之间的摩擦差异。被辐照的区域显示出的摩擦力比被遮盖的区域要低,而没有观察到这些区域之间的明显的高度对比。摩擦的减少归因于COOH和COOCH 3的转化成分较少的粘合成分,例如C = O和CH 3。这些实验表明,HV-VUV处理可作为在受到酸和酯基终止的表面上进行低损伤干表面改性和还原性光刻技术的方法。











































 京公网安备 11010802027423号
京公网安备 11010802027423号