当前位置:
X-MOL 学术
›
ACS Photonics
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Generated Carrier Dynamics in V-Pit-Enhanced InGaN/GaN Light-Emitting Diode
ACS Photonics ( IF 6.5 ) Pub Date : 2017-12-18 00:00:00 , DOI: 10.1021/acsphotonics.7b00944 Idris A. Ajia 1 , Paul R. Edwards 2 , Yusin Pak 1 , Ermek Belekov 1 , Manuel A. Roldan 3 , Nini Wei 3 , Zhiqiang Liu 4 , Robert W. Martin 2 , Iman S. Roqan 1
ACS Photonics ( IF 6.5 ) Pub Date : 2017-12-18 00:00:00 , DOI: 10.1021/acsphotonics.7b00944 Idris A. Ajia 1 , Paul R. Edwards 2 , Yusin Pak 1 , Ermek Belekov 1 , Manuel A. Roldan 3 , Nini Wei 3 , Zhiqiang Liu 4 , Robert W. Martin 2 , Iman S. Roqan 1
Affiliation
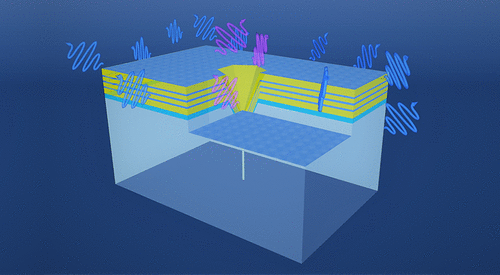
|
We investigate the effects of V-pits on the optical properties of a state-of-the-art, highly efficient, blue InGaN/GaN multi-quantum-well (MQW) light-emitting diode (LED) with a high internal quantum efficiency (IQE) of >80%. The LED is structurally enhanced by incorporating a pre-MQW InGaN strain-relief layer with low InN content and a patterned sapphire substrate. For comparison, a conventional (unenhanced) InGaN/GaN MQW LED (with an IQE of 46%) grown under similar conditions was subjected to the same measurements. Scanning transmission electron microscopy reveals the absence of V-pits in the unenhanced LED, whereas in the enhanced LED, V-pits with {10-11} facets, emerging from threading dislocations (TDs), were prominent. Cathodoluminescence mapping reveals the luminescence properties near the V-pits, showing that the formation of V-pit defects can encourage the growth of defect-neutralizing barriers around TD defect states. The diminished contribution of TDs in the MQWs allows indium-rich localization sites to act as efficient recombination centers. Photoluminescence and time-resolved spectroscopy measurements suggest that the V-pits play a significant role in the generated carrier rate and droop mechanism, showing that the quantum-confined Stark effect is suppressed at low generated carrier density, after which the carrier dynamics and droop are governed by the carrier overflow effect.
中文翻译:

V坑增强的InGaN / GaN发光二极管中产生的载流子动力学
我们研究了V凹坑对具有高内部量子效率的最新,高效,蓝色InGaN / GaN多量子阱(MQW)发光二极管(LED)的光学特性的影响(IQE)> 80%。通过合并具有低InN含量的预MQW InGaN应变消除层和带图案的蓝宝石衬底,可以在结构上增强LED。为了进行比较,对在相似条件下生长的常规(增强型)InGaN / GaN MQW LED(IQE为46%)进行了相同的测量。扫描透射电子显微镜显示在未增强的LED中不存在V形凹坑,而在增强型LED中,由螺纹位错(TD)出现的具有{10-11}刻面的V形凹坑是突出的。阴极发光映射揭示了V形凹坑附近的发光特性,表明形成V坑缺陷可以促进TD缺陷状态周围缺陷中和势垒的生长。量子阱中TD的贡献减少,使得富含铟的定位位点可以充当有效的重组中心。光致发光和时间分辨光谱测量表明,V坑在生成的载流子速率和下垂机理中起着重要作用,表明在低生成的载流子密度下,量子限制的斯塔克效应受到抑制,此后载流子动力学和下垂被抑制。由载波溢出效应决定。
更新日期:2017-12-18
中文翻译:

V坑增强的InGaN / GaN发光二极管中产生的载流子动力学
我们研究了V凹坑对具有高内部量子效率的最新,高效,蓝色InGaN / GaN多量子阱(MQW)发光二极管(LED)的光学特性的影响(IQE)> 80%。通过合并具有低InN含量的预MQW InGaN应变消除层和带图案的蓝宝石衬底,可以在结构上增强LED。为了进行比较,对在相似条件下生长的常规(增强型)InGaN / GaN MQW LED(IQE为46%)进行了相同的测量。扫描透射电子显微镜显示在未增强的LED中不存在V形凹坑,而在增强型LED中,由螺纹位错(TD)出现的具有{10-11}刻面的V形凹坑是突出的。阴极发光映射揭示了V形凹坑附近的发光特性,表明形成V坑缺陷可以促进TD缺陷状态周围缺陷中和势垒的生长。量子阱中TD的贡献减少,使得富含铟的定位位点可以充当有效的重组中心。光致发光和时间分辨光谱测量表明,V坑在生成的载流子速率和下垂机理中起着重要作用,表明在低生成的载流子密度下,量子限制的斯塔克效应受到抑制,此后载流子动力学和下垂被抑制。由载波溢出效应决定。











































 京公网安备 11010802027423号
京公网安备 11010802027423号