Our official English website, www.x-mol.net, welcomes your feedback! (Note: you will need to create a separate account there.)
Area-Selective Atomic Layer Deposition of SiO2 Using Acetylacetone as a Chemoselective Inhibitor in an ABC-Type Cycle
ACS Nano ( IF 17.1 ) Pub Date : 2017-09-07 00:00:00 , DOI: 10.1021/acsnano.7b04701 Alfredo Mameli 1 , Marc J. M. Merkx 1 , Bora Karasulu 1 , Fred Roozeboom 1, 2 , Wilhelmus (Erwin) M. M. Kessels 1 , Adriaan J. M. Mackus 1
ACS Nano ( IF 17.1 ) Pub Date : 2017-09-07 00:00:00 , DOI: 10.1021/acsnano.7b04701 Alfredo Mameli 1 , Marc J. M. Merkx 1 , Bora Karasulu 1 , Fred Roozeboom 1, 2 , Wilhelmus (Erwin) M. M. Kessels 1 , Adriaan J. M. Mackus 1
Affiliation
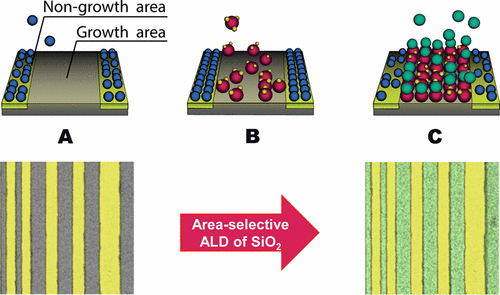
|
Area-selective atomic layer deposition (ALD) is rapidly gaining interest because of its potential application in self-aligned fabrication schemes for next-generation nanoelectronics. Here, we introduce an approach for area-selective ALD that relies on the use of chemoselective inhibitor molecules in a three-step (ABC-type) ALD cycle. A process for area-selective ALD of SiO2 was developed comprising acetylacetone inhibitor (step A), bis(diethylamino)silane precursor (step B), and O2 plasma reactant (step C) pulses. Our results show that this process allows for selective deposition of SiO2 on GeO2, SiNx, SiO2, and WO3, in the presence of Al2O3, TiO2, and HfO2 surfaces. In situ Fourier transform infrared spectroscopy experiments and density functional theory calculations underline that the selectivity of the approach stems from the chemoselective adsorption of the inhibitor. The selectivity between different oxide starting surfaces and the compatibility with plasma-assisted or ozone-based ALD are distinct features of this approach. Furthermore, the approach offers the opportunity of tuning the substrate-selectivity by proper selection of inhibitor molecules.
中文翻译:

在ABC型循环中使用乙酰丙酮作为化学选择性抑制剂对SiO 2进行区域选择性原子层沉积
区域选择性原子层沉积(ALD)迅速引起人们的兴趣,因为它潜在地应用于下一代纳米电子器件的自对准制造方案中。在这里,我们介绍一种区域选择性ALD方法,该方法依赖于在三步(ABC型)ALD循环中使用化学选择性抑制剂分子。开发了用于SiO 2的区域选择性ALD的方法,该方法包括乙酰丙酮抑制剂(步骤A),双(二乙基氨基)硅烷前体(步骤B)和O 2等离子体反应物(步骤C)脉冲。我们的结果表明,该过程允许在存在Al 2的情况下在GeO 2,SiN x,SiO 2和WO 3上选择性沉积SiO 2。O 3,TiO 2和HfO 2表面。原位傅里叶变换红外光谱实验和密度泛函理论计算结果表明,该方法的选择性源于抑制剂的化学选择性吸附。不同氧化物起始表面之间的选择性以及与等离子体辅助或基于臭氧的ALD的相容性是该方法的显着特征。此外,该方法提供通过抑制剂分子的适当选择调谐基板选择性的机会。
更新日期:2017-09-07
中文翻译:

在ABC型循环中使用乙酰丙酮作为化学选择性抑制剂对SiO 2进行区域选择性原子层沉积
区域选择性原子层沉积(ALD)迅速引起人们的兴趣,因为它潜在地应用于下一代纳米电子器件的自对准制造方案中。在这里,我们介绍一种区域选择性ALD方法,该方法依赖于在三步(ABC型)ALD循环中使用化学选择性抑制剂分子。开发了用于SiO 2的区域选择性ALD的方法,该方法包括乙酰丙酮抑制剂(步骤A),双(二乙基氨基)硅烷前体(步骤B)和O 2等离子体反应物(步骤C)脉冲。我们的结果表明,该过程允许在存在Al 2的情况下在GeO 2,SiN x,SiO 2和WO 3上选择性沉积SiO 2。O 3,TiO 2和HfO 2表面。原位傅里叶变换红外光谱实验和密度泛函理论计算结果表明,该方法的选择性源于抑制剂的化学选择性吸附。不同氧化物起始表面之间的选择性以及与等离子体辅助或基于臭氧的ALD的相容性是该方法的显着特征。此外,该方法提供通过抑制剂分子的适当选择调谐基板选择性的机会。



























 京公网安备 11010802027423号
京公网安备 11010802027423号