Current Applied Physics ( IF 2.4 ) Pub Date : 2021-03-31 , DOI: 10.1016/j.cap.2021.03.019 Khushabu Agrawal , Vilas Patil , Fida Ali , Matheus Rabelo , Won Jong Yoo , Eun-Chel Cho , Junsin Yi
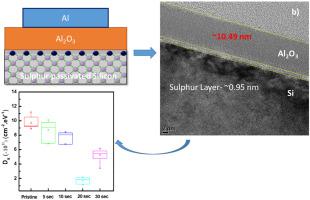
|
The HF treatment removes the native oxide and lays behind the dangling bonds over the Si surface which causes the increment in density of interface traps (Dit) through the direct deposition of high-k dielectric on Si. Here, we propose the facile method for reduction of interface traps and improvement in barrier height with the (NH4)2S treatment on Al2O3/Si interfaces, which can be used as the base for the non-volatile memory device. The AFM was used to optimize the treatment time and surface properties, while XPS measurements were carried out to study the interface and extract the barrier height (ΦB). The short period of 20 s treatment shows the improvement in the barrier height (1.02 eV), while the one order reduction in the Dit (0.84 × 1012 cm2/eV) of sulfur passivated Al/Al2O3/Si MOS device. The results indicate the favorable passivation of the dangling bonds over the Si surfaces covered by sulfur atoms.
中文翻译:

硫化铵处理的Al 2 O 3 / Si界面的界面态密度和势垒高度的提高
HF处理去除了天然氧化物,并在Si表面上方的悬空键后面,这通过在硅上直接沉积高k电介质而导致界面陷阱密度(D it)的增加。在此,我们提出了一种在Al 2 O 3 / Si界面上通过(NH 4)2 S处理减少界面陷阱并提高势垒高度的简便方法,该方法可用作非易失性存储器件的基础。所述AFM用于优化处理时间和表面特性,而XPS测量进行了研究接口和提取的势垒高度(Φ乙)。20 s的短时间处理表明,势垒高度(1.02 eV)有所提高,而硫钝化的Al / Al 2 O 3 / Si MOS的D it降低了一个数量级(0.84×10 12 cm 2 / eV)。设备。结果表明在被硫原子覆盖的Si表面上的悬空键具有良好的钝化作用。


























 京公网安备 11010802027423号
京公网安备 11010802027423号