当前位置:
X-MOL 学术
›
Phys. Status Solidi. Rapid Res. Lett.
›
论文详情
Our official English website, www.x-mol.net, welcomes your feedback! (Note: you will need to create a separate account there.)
Area‐Selective Atomic Layer Deposition of MoS2 using Simultaneous Deposition and Etching Characteristics of MoCl5
Physica Status Solidi-Rapid Research Letters ( IF 2.8 ) Pub Date : 2020-12-29 , DOI: 10.1002/pssr.202000533 Wonsik Ahn 1 , Hyangsook Lee 1, 2 , Hoijoon Kim 1 , Mirine Leem 1 , Heesoo Lee 1 , Taejin Park 3 , Eunha Lee 2 , Hyoungsub Kim 1
Physica Status Solidi-Rapid Research Letters ( IF 2.8 ) Pub Date : 2020-12-29 , DOI: 10.1002/pssr.202000533 Wonsik Ahn 1 , Hyangsook Lee 1, 2 , Hoijoon Kim 1 , Mirine Leem 1 , Heesoo Lee 1 , Taejin Park 3 , Eunha Lee 2 , Hyoungsub Kim 1
Affiliation
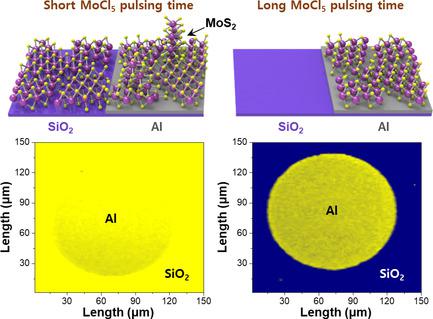
|
A novel selective atomic layer deposition (ALD) process for depositing MoS2 using MoCl5 and H2S precursors is proposed. On the surface of SiO2, the prolonged introduction of MoCl5 vapor by increasing the MoCl5 pulsing time rapidly suppresses the subsequent MoS2 growth due to the intense self‐etching effect of MoCl5, that is, the detachment of weakly bonded surface adsorbates (MoClx*). In contrast, the surface of Al allows more facile adsorption of MoCl5 than in the case of the SiO2 surface, and thus effectively compensates for the reduced deposition rate. By optimizing the MoCl5 pulsing time, the self‐aligned growth of MoS2 on predefined Al (5 nm) patterns (circular and letter patterns) on a SiO2 substrate with a negligible selectivity loss is demonstrated.
中文翻译:

利用MoCl5的同时沉积和蚀刻特性沉积MoS2的区域选择性原子层沉积
提出了一种使用MoCl 5和H 2 S前驱体沉积MoS 2的新型选择性原子层沉积(ALD)工艺。在SiO的表面2中,延长引入代替MoCl的5蒸气通过增加代替MoCl 5脉冲时间迅速抑制后续的MoS 2生长,由于代替MoCl的强烈自蚀刻效应5,即,弱结合表面吸附物的脱离(MoCl x *)。相比之下,与SiO 2相比,Al的表面更容易吸附MoCl 5表面,因此有效地补偿了降低的沉积速率。通过优化MoCl 5脉冲时间,证明了MoS 2在SiO 2衬底上的预定Al(5 nm)图案(圆形和字母图案)上的自对准生长,选择性损失可忽略不计。
更新日期:2021-02-09
中文翻译:

利用MoCl5的同时沉积和蚀刻特性沉积MoS2的区域选择性原子层沉积
提出了一种使用MoCl 5和H 2 S前驱体沉积MoS 2的新型选择性原子层沉积(ALD)工艺。在SiO的表面2中,延长引入代替MoCl的5蒸气通过增加代替MoCl 5脉冲时间迅速抑制后续的MoS 2生长,由于代替MoCl的强烈自蚀刻效应5,即,弱结合表面吸附物的脱离(MoCl x *)。相比之下,与SiO 2相比,Al的表面更容易吸附MoCl 5表面,因此有效地补偿了降低的沉积速率。通过优化MoCl 5脉冲时间,证明了MoS 2在SiO 2衬底上的预定Al(5 nm)图案(圆形和字母图案)上的自对准生长,选择性损失可忽略不计。


























 京公网安备 11010802027423号
京公网安备 11010802027423号