当前位置:
X-MOL 学术
›
J. Appl. Crystallogr.
›
论文详情
Our official English website, www.x-mol.net, welcomes your feedback! (Note: you will need to create a separate account there.)
Electric-field-intensity-modulated scattering as a thin-film depth probe
Journal of Applied Crystallography ( IF 6.1 ) Pub Date : 2020-11-05 , DOI: 10.1107/s1600576720013047 Peter J. Dudenas , Adam Z. Weber , Ahmet Kusoglu
Journal of Applied Crystallography ( IF 6.1 ) Pub Date : 2020-11-05 , DOI: 10.1107/s1600576720013047 Peter J. Dudenas , Adam Z. Weber , Ahmet Kusoglu
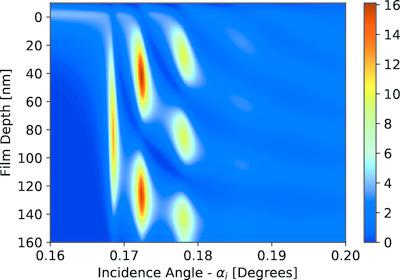
|
Grazing incidence x-ray scattering provides nanostructural information for thin film samples, but single images generally do not provide information on film thickness or the full complex index of refraction. Additionally, for thin films that possess stratification of scatterers vertically within a sample, it can be difficult to determine where those scatterers are positioned. We present an in-situ method to extract film thickness, the index of refraction, and depth information using scattering images taken across a range of incident angles. The underlying theory is presented, and we validate the technique using two sets of polymer thin films. Finally, we discuss how it can be implemented as a general beamline procedure. This technique is applicable to any thin-film material and has potentially far-reaching impact by enabling depth-sensitive information in situ at any grazing incidence-capable beamline.
中文翻译:

作为薄膜深度探测器的电场强度调制散射
掠入射 X 射线散射为薄膜样品提供纳米结构信息,但单幅图像通常不提供有关薄膜厚度或完整复数折射率的信息。此外,对于在样品内具有散射体垂直分层的薄膜,可能难以确定这些散射体的位置。我们提出了一种使用在一系列入射角范围内拍摄的散射图像来提取薄膜厚度、折射率和深度信息的原位方法。提出了基本理论,我们使用两组聚合物薄膜验证了该技术。最后,我们讨论如何将其作为通用光束线程序来实施。
更新日期:2020-11-05
中文翻译:

作为薄膜深度探测器的电场强度调制散射
掠入射 X 射线散射为薄膜样品提供纳米结构信息,但单幅图像通常不提供有关薄膜厚度或完整复数折射率的信息。此外,对于在样品内具有散射体垂直分层的薄膜,可能难以确定这些散射体的位置。我们提出了一种使用在一系列入射角范围内拍摄的散射图像来提取薄膜厚度、折射率和深度信息的原位方法。提出了基本理论,我们使用两组聚合物薄膜验证了该技术。最后,我们讨论如何将其作为通用光束线程序来实施。



























 京公网安备 11010802027423号
京公网安备 11010802027423号