当前位置:
X-MOL 学术
›
Comp. Mater. Sci.
›
论文详情
Our official English website, www.x-mol.net, welcomes your feedback! (Note: you will need to create a separate account there.)
Multi-phase-field modelling of electromigration-induced void migration in interconnect lines having bamboo structures
Computational Materials Science ( IF 3.3 ) Pub Date : 2020-11-01 , DOI: 10.1016/j.commatsci.2020.109848 Akimitsu Ishii , Akinori Yamanaka
Computational Materials Science ( IF 3.3 ) Pub Date : 2020-11-01 , DOI: 10.1016/j.commatsci.2020.109848 Akimitsu Ishii , Akinori Yamanaka
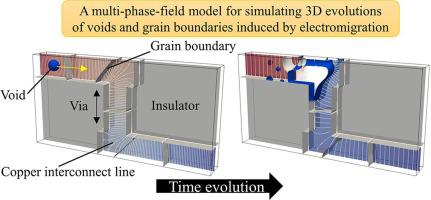
|
Abstract Predicting the evolution of voids induced by electromigration (EM) in interconnect lines is an important aspect of improving the reliability of miniaturized integrated circuits. In this paper, we propose a new multi-phase-field (MPF) model to simulate void evolution in polycrystalline interconnect lines on a three-dimensional (3D) basis. This model was validated by comparing simulations of 3D void migration in a single crystal copper line with analytical solutions. We also performed a parametric study intended to elucidate the key factors associated with void evolution leading to line breakage. This study determined that critical void evolution in copper straight interconnect lines having a bamboo structure depends on the ratio of the diffusion coefficient of atoms at the grain boundaries to that at the void surfaces. Simulations in which multiple voids migrated by EM in a bamboo line mimicking a via site in an integrated circuit showed that such voids tend to accumulate and break the interconnect line above the via. By comparing simulation results to experimental data, this work also confirmed that the MPF model can predict the break point of an interconnect line as caused by EM.
中文翻译:

具有竹结构的互连线中电迁移引起的空隙迁移的多相场建模
摘要 预测互连线中由电迁移 (EM) 引起的空洞的演变是提高小型化集成电路可靠性的一个重要方面。在本文中,我们提出了一种新的多相场 (MPF) 模型,以在三维 (3D) 基础上模拟多晶互连线中的空隙演化。通过将单晶铜线中 3D 空隙迁移的模拟与解析解进行比较,验证了该模型。我们还进行了一项参数研究,旨在阐明与导致断线的空隙演变相关的关键因素。该研究确定,具有竹结构的铜直互连线中的临界空隙演化取决于晶界处原子的扩散系数与空隙表面处的原子扩散系数之比。在模拟集成电路中的过孔位置的竹线中,多个空隙由 EM 迁移的模拟表明,此类空隙往往会积聚并破坏过孔上方的互连线。通过将仿真结果与实验数据进行比较,这项工作还证实了 MPF 模型可以预测由 EM 引起的互连线的断点。
更新日期:2020-11-01
中文翻译:

具有竹结构的互连线中电迁移引起的空隙迁移的多相场建模
摘要 预测互连线中由电迁移 (EM) 引起的空洞的演变是提高小型化集成电路可靠性的一个重要方面。在本文中,我们提出了一种新的多相场 (MPF) 模型,以在三维 (3D) 基础上模拟多晶互连线中的空隙演化。通过将单晶铜线中 3D 空隙迁移的模拟与解析解进行比较,验证了该模型。我们还进行了一项参数研究,旨在阐明与导致断线的空隙演变相关的关键因素。该研究确定,具有竹结构的铜直互连线中的临界空隙演化取决于晶界处原子的扩散系数与空隙表面处的原子扩散系数之比。在模拟集成电路中的过孔位置的竹线中,多个空隙由 EM 迁移的模拟表明,此类空隙往往会积聚并破坏过孔上方的互连线。通过将仿真结果与实验数据进行比较,这项工作还证实了 MPF 模型可以预测由 EM 引起的互连线的断点。


























 京公网安备 11010802027423号
京公网安备 11010802027423号