当前位置:
X-MOL 学术
›
ACS Appl. Mater. Interfaces
›
论文详情
Our official English website, www.x-mol.net, welcomes your feedback! (Note: you will need to create a separate account there.)
Monolithically Integrated Enhancement-Mode and Depletion-Mode β-Ga2O3 MESFETs with Graphene-Gate Architectures and Their Logic Applications.
ACS Applied Materials & Interfaces ( IF 9.5 ) Pub Date : 2020-01-16 , DOI: 10.1021/acsami.9b19667 Janghyuk Kim 1 , Jihyun Kim 1
ACS Applied Materials & Interfaces ( IF 9.5 ) Pub Date : 2020-01-16 , DOI: 10.1021/acsami.9b19667 Janghyuk Kim 1 , Jihyun Kim 1
Affiliation
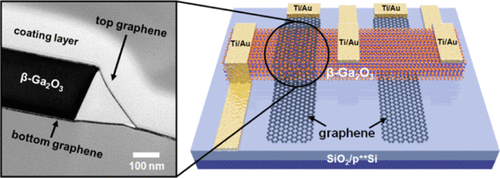
|
Ultrawide band gap (UWBG) β-Ga2O3 is a promising material for next-generation power electronic devices. An enhancement-mode (E-mode) device is essential for designing power conversion systems with simplified circuitry and minimal loss. The integration of an E-mode field-effect transistor (FET) with a depletion-mode (D-mode) FET can build a high-performance logic circuit. In this study, we first demonstrated the realization of an E-mode quasi-two-dimensional (quasi-2D) β-Ga2O3 FET with a novel graphene gate architecture via a van der Waals heterojunction. Then, we monolithically integrated it with a D-mode quasi-2D β-Ga2O3 FET, achieving an area-efficient logic circuit. The threshold voltage of the n-channel UWBG β-Ga2O3 material was controlled by forming a novel architecture of a double-gate graphene/β-Ga2O3 heterojunction, where both graphene and β-Ga2O3 were obtained by a mechanical exfoliation method. The fabricated double graphene-gate β-Ga2O3 metal-semiconductor FET (MESFET) was operated in the E-mode with a positive threshold voltage of +0.25 V, which is approximately 1.2 V higher than that of a single-gate D-mode β-Ga2O3 MESFET. Both E-/D-modes β-Ga2O3 MESFETs showed excellent electrical characteristics with a subthreshold swing of 68.9 and 84.6 mV/dec, respectively, and a high on/off current ratio of approximately 107. A β-Ga2O3 logic inverter composed of E-/D-mode β-Ga2O3 devices exhibited desired inversion characteristics. The monolithic integration of an E-/D-mode quasi-2D FET with an UWBG channel layer can pave the way for various applications in smart and robust power (nano) electronics.
中文翻译:

具有石墨烯-门架构的单片集成增强模式和耗尽模式β-Ga2O3MESFET及其逻辑应用。
超宽带隙(UWBG)β-Ga2O3是下一代电力电子设备的有前途的材料。增强模式(E模式)设备对于设计具有简化电路和最小损耗的电源转换系统至关重要。E模式场效应晶体管(FET)与耗尽模式(D模式)FET的集成可以构建高性能逻辑电路。在这项研究中,我们首先展示了通过范德华异质结实现具有新颖石墨烯栅极结构的E模式准二维(准2D)β-Ga2O3FET的实现。然后,我们将其与D模式准2Dβ-Ga2O3FET单片集成,从而实现了面积有效的逻辑电路。n沟道UWBGβ-Ga2O3材料的阈值电压通过形成双栅石墨烯/β-Ga2O3异质结的新型结构来控制,其中石墨烯和β-Ga2O3均通过机械剥离法获得。所制造的双石墨烯栅极β-Ga2O3金属半导体FET(MESFET)在E模式下以+0.25 V的正阈值电压工作,该阈值电压比单栅极D模式β的正阈值电压高约1.2 V -Ga2O3 MESFET。两种E / D模式的β-Ga2O3MESFET均具有出色的电气特性,其亚阈值摆幅分别为68.9和84.6 mV / dec,以及高的开/关电流比约为107。由E组成的β-Ga2O3逻辑反相器-/ D模式的β-Ga2O3器件表现出所需的反转特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。所制造的双石墨烯栅极β-Ga2O3金属半导体FET(MESFET)在E模式下以+0.25 V的正阈值电压工作,该阈值电压比单栅极D模式β的正阈值电压高约1.2 V -Ga2O3 MESFET。两种E / D模式的β-Ga2O3MESFET均具有出色的电气特性,其亚阈值摆幅分别为68.9和84.6 mV / dec,以及高的开/关电流比约为107。由E组成的β-Ga2O3逻辑反相器-/ D模式的β-Ga2O3器件表现出所需的反转特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。所制造的双石墨烯栅极β-Ga2O3金属半导体FET(MESFET)在E模式下以+0.25 V的正阈值电压工作,该阈值电压比单栅极D模式β的正阈值电压高约1.2 V -Ga2O3 MESFET。两种E / D模式的β-Ga2O3MESFET均具有出色的电气特性,其亚阈值摆幅分别为68.9和84.6 mV / dec,以及高的开/关电流比约为107。由E组成的β-Ga2O3逻辑反相器-/ D模式的β-Ga2O3器件表现出所需的反转特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。它比单栅D型β-Ga2O3MESFET高约1.2V。两种E / D模式的β-Ga2O3MESFET均具有出色的电气特性,其亚阈值摆幅分别为68.9和84.6 mV / dec,以及高的开/关电流比约为107。由E组成的β-Ga2O3逻辑反相器-/ D模式的β-Ga2O3器件表现出所需的反转特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。它比单栅D型β-Ga2O3MESFET高约1.2V。两种E / D模式的β-Ga2O3MESFET均具有出色的电气特性,其亚阈值摆幅分别为68.9和84.6 mV / dec,以及高的开/关电流比约为107。由E组成的β-Ga2O3逻辑反相器-/ D模式的β-Ga2O3器件表现出所需的反转特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。由E- / D模式的β-Ga2O3器件组成的β-Ga2O3逻辑反相器表现出所需的反相特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。由E- / D模式的β-Ga2O3器件组成的β-Ga2O3逻辑反相器表现出所需的反相特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。
更新日期:2020-01-17
中文翻译:

具有石墨烯-门架构的单片集成增强模式和耗尽模式β-Ga2O3MESFET及其逻辑应用。
超宽带隙(UWBG)β-Ga2O3是下一代电力电子设备的有前途的材料。增强模式(E模式)设备对于设计具有简化电路和最小损耗的电源转换系统至关重要。E模式场效应晶体管(FET)与耗尽模式(D模式)FET的集成可以构建高性能逻辑电路。在这项研究中,我们首先展示了通过范德华异质结实现具有新颖石墨烯栅极结构的E模式准二维(准2D)β-Ga2O3FET的实现。然后,我们将其与D模式准2Dβ-Ga2O3FET单片集成,从而实现了面积有效的逻辑电路。n沟道UWBGβ-Ga2O3材料的阈值电压通过形成双栅石墨烯/β-Ga2O3异质结的新型结构来控制,其中石墨烯和β-Ga2O3均通过机械剥离法获得。所制造的双石墨烯栅极β-Ga2O3金属半导体FET(MESFET)在E模式下以+0.25 V的正阈值电压工作,该阈值电压比单栅极D模式β的正阈值电压高约1.2 V -Ga2O3 MESFET。两种E / D模式的β-Ga2O3MESFET均具有出色的电气特性,其亚阈值摆幅分别为68.9和84.6 mV / dec,以及高的开/关电流比约为107。由E组成的β-Ga2O3逻辑反相器-/ D模式的β-Ga2O3器件表现出所需的反转特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。所制造的双石墨烯栅极β-Ga2O3金属半导体FET(MESFET)在E模式下以+0.25 V的正阈值电压工作,该阈值电压比单栅极D模式β的正阈值电压高约1.2 V -Ga2O3 MESFET。两种E / D模式的β-Ga2O3MESFET均具有出色的电气特性,其亚阈值摆幅分别为68.9和84.6 mV / dec,以及高的开/关电流比约为107。由E组成的β-Ga2O3逻辑反相器-/ D模式的β-Ga2O3器件表现出所需的反转特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。所制造的双石墨烯栅极β-Ga2O3金属半导体FET(MESFET)在E模式下以+0.25 V的正阈值电压工作,该阈值电压比单栅极D模式β的正阈值电压高约1.2 V -Ga2O3 MESFET。两种E / D模式的β-Ga2O3MESFET均具有出色的电气特性,其亚阈值摆幅分别为68.9和84.6 mV / dec,以及高的开/关电流比约为107。由E组成的β-Ga2O3逻辑反相器-/ D模式的β-Ga2O3器件表现出所需的反转特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。它比单栅D型β-Ga2O3MESFET高约1.2V。两种E / D模式的β-Ga2O3MESFET均具有出色的电气特性,其亚阈值摆幅分别为68.9和84.6 mV / dec,以及高的开/关电流比约为107。由E组成的β-Ga2O3逻辑反相器-/ D模式的β-Ga2O3器件表现出所需的反转特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。它比单栅D型β-Ga2O3MESFET高约1.2V。两种E / D模式的β-Ga2O3MESFET均具有出色的电气特性,其亚阈值摆幅分别为68.9和84.6 mV / dec,以及高的开/关电流比约为107。由E组成的β-Ga2O3逻辑反相器-/ D模式的β-Ga2O3器件表现出所需的反转特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。由E- / D模式的β-Ga2O3器件组成的β-Ga2O3逻辑反相器表现出所需的反相特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。由E- / D模式的β-Ga2O3器件组成的β-Ga2O3逻辑反相器表现出所需的反相特性。E / D模式准2D FET与UWBG沟道层的单片集成可以为智能和鲁棒性电源(纳米)电子产品中的各种应用铺平道路。

























 京公网安备 11010802027423号
京公网安备 11010802027423号