Our official English website, www.x-mol.net, welcomes your feedback! (Note: you will need to create a separate account there.)
Stress-engineered growth of homoepitaxial GaN crystals using hydride vapor phase epitaxy
RSC Advances ( IF 3.9 ) Pub Date : 2018-10-17 00:00:00 , DOI: 10.1039/c8ra06438e Moonsang Lee 1 , Sungsoo Park 2, 3
RSC Advances ( IF 3.9 ) Pub Date : 2018-10-17 00:00:00 , DOI: 10.1039/c8ra06438e Moonsang Lee 1 , Sungsoo Park 2, 3
Affiliation
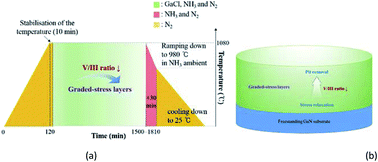
|
We report the growth of a 3.5 mm-thick bulk GaN layer using a stress-engineered homoepitaxy method without any external processes. We employ a gradient V/III ratio during the growth, which enables a 3.5 mm-thick bulk GaN layer with a smooth surface and high crystal quality to be obtained. For a constant V/III ratio of 10, the bulk GaN layer has a flat surface; however, microcracks emerge in the GaN layer. For a constant V/III ratio of 38, the bulk GaN layer has a rough surface, without microcracks. On the other hand, by decreasing the V/III ratio from 38 to 10, the structural properties of the GaN layers are successfully controlled. The higher V/III ratio in the initial growth stage leads to a rough surface, and reduced stress and dislocation density in the bulk GaN layers, while the lower V/III ratio in the second stage of the growth provides an opposite trend, confirmed by Raman spectroscopy and X-ray measurements. We expect that this study will offer a new opportunity to achieve the growth of high-crystallinity bulk GaN without ex situ and complicated processes.
中文翻译:

使用氢化物气相外延的同质外延 GaN 晶体的应力工程生长
我们报告了使用应力工程同质外延方法生长 3.5 mm 厚的体 GaN 层,而无需任何外部工艺。我们在生长过程中采用梯度 V/III 比率,这使得能够获得具有光滑表面和高晶体质量的 3.5 mm 厚的块体 GaN 层。对于 10 的恒定 V/III 比,体 GaN 层具有平坦的表面;然而,在 GaN 层中会出现微裂纹。对于 38 的恒定 V/III 比率,体 GaN 层具有粗糙表面,没有微裂纹。另一方面,通过将 V/III 比率从 38 降低到 10,成功地控制了 GaN 层的结构特性。初始生长阶段较高的 V/III 比会导致表面粗糙,并降低体 GaN 层中的应力和位错密度,而在生长的第二阶段较低的 V/III 比率则提供了相反的趋势,这已通过拉曼光谱和 X 射线测量得到证实。我们预计这项研究将为实现高结晶体 GaN 的生长提供一个新的机会,而无需异地和复杂的过程。
更新日期:2018-10-17
中文翻译:

使用氢化物气相外延的同质外延 GaN 晶体的应力工程生长
我们报告了使用应力工程同质外延方法生长 3.5 mm 厚的体 GaN 层,而无需任何外部工艺。我们在生长过程中采用梯度 V/III 比率,这使得能够获得具有光滑表面和高晶体质量的 3.5 mm 厚的块体 GaN 层。对于 10 的恒定 V/III 比,体 GaN 层具有平坦的表面;然而,在 GaN 层中会出现微裂纹。对于 38 的恒定 V/III 比率,体 GaN 层具有粗糙表面,没有微裂纹。另一方面,通过将 V/III 比率从 38 降低到 10,成功地控制了 GaN 层的结构特性。初始生长阶段较高的 V/III 比会导致表面粗糙,并降低体 GaN 层中的应力和位错密度,而在生长的第二阶段较低的 V/III 比率则提供了相反的趋势,这已通过拉曼光谱和 X 射线测量得到证实。我们预计这项研究将为实现高结晶体 GaN 的生长提供一个新的机会,而无需异地和复杂的过程。


























 京公网安备 11010802027423号
京公网安备 11010802027423号